страница 1 страница 2 страница 3
Параметры плазмы ВЧ-разряда и их пространственное распределение
Известно [17, 18], что функция распределения электронов по энергиям (ФРЭЭ) в плазме ВЧ-разряда fe() может существенно отличаться от максвелловской наличием высокоэнергетичного максимума, т.е. являться бимодальной. Предложенный [17, 18] механизм возникновения пучков быстрых электронов в приэлектродных областях, согласно которому ускорение происходит при выталкивании электронов во время отрицательных импульсов потенциала на электродах, следующих с частотой ВЧ поля, убедительно подтверждается имеющейся совокупностью экспериментальных данных. Теоретическое рассмотрение диссипации энергии ВЧ поля в приэлектродном слое, сопровождающееся статистическим ускорением электронов при их неупругом взаимодействии с осциллирующим потенциальным барьером, для малых ВЧ напряжений (VВЧ < 5 Ve) проведено В.А. Годяком [18].
На рис. 1.15 дано качественное построение разности потенциалов между электродом и плазмой V(t), которое слагается в каждый момент времени из приложенного ВЧ потенциала и постоянной отрицательной составляющей потенциала электрода 0, равной по величине потенциалу пространства V0. Там же приведены предполагаемы осцилляции интенсивности свечения плазмы в приэлектродных областях (3, 4). Слабая осцилляция интенсивности излучения IP (3) обусловлена периодической поляризацией плазмы вблизи электрода под действием внешнего ВЧ поля, гораздо более значительная пульсация интенсивности свечения Ib (4) обусловлена пучками быстрых электронов, генерируемых во время отрицательных импульсов V(t). Потоки ускоренных электронов выталкиваемых этими импульсами из приэлектродной области в плазму состоят из выбитых электродов в результате -процессов и электронов, ранее пришедших из плазмы. В силу того, что амплитуда отрицательных импульсов достигает сотен вольт, следует ожидать приобретение выталкиваемыми электронами значительной энергии, существенно превосходящей потенциалы возбуждения и ионизации атомов и молекул плазмы. Поэтому естественно предположить указанный на рис. 1.15 (5) характер изменения интенсивности свечения Iсв(t) приэлектродных областей плазмы, что полностью подтверждается полученными осциллограммами свечения (6) плазмы из обоих разрядных электродов [21].
При увеличении ВЧ напряжения амплитуда и область осцилляции свечения с частотой увеличиваются (рис. 1.16), так как увеличивается энергия выталкиваемых электронов и глубина их проникновения в плазму. Здесь и далее VВЧ – эффективное значение ВЧ напряжения.
С изменением ВЧ напряжения, безусловно, меняется и функция распределения электронов по энергиям fe() в какой-либо локальной области плазмы вследствие увеличения или уменьшения генерации пучков быстрых электронов в приэлектродных областях. Сказанное наглядно иллюстрируется рис. 1.17 [22]. При увеличении приложенного ВЧ напряжения в энергетическом спектре электронов плазмы появляется высокоэнергетичная вторая мода, максимум которой смещается в область больших энергий с ростом значения амплитуды VВЧ высокочастотного напряжения. Такое изменение ФРЭЭ в центральной области разряда ведет и к соответствующему изменению пространственного распределения светимости. Постоянная составляющая светимости с ростом VВЧ увеличиваются, вместе с тем расширяются наиболее интенсивно светящиеся приэлектродные области (рис. 1.18), что может привести к исчезновению относительно тусклой центральной области разряда, являющейся аналогом положительного столба разряда на постоянном токе. При раздвижении электродов указанная слабосветящаяся центральная область увеличивается.

Рис. 1.15. Временные зависимости переменной составляющей потенциала электрода (t) и суммарного потенциала V(t) = 0 + (t) (2), а также предполагаемые зависимости интенсивностей свечений Ip (обусловленной поляризацией плазмы – 3) и Ib (обусловленной пульсирующими потоками быстрых электронов – 4) и их суммы  (5) c осциллограммами временных пульсаций интенсивности свечения плазмы ВЧ-Е-разряда у обоих электродов (6) [18]. (5) c осциллограммами временных пульсаций интенсивности свечения плазмы ВЧ-Е-разряда у обоих электродов (6) [18].
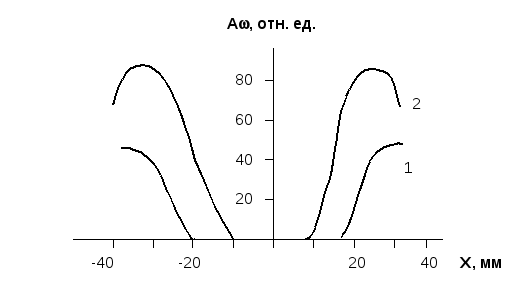
Рис. 1.16. Распределение амплитуды A осцилляции интенсивности свечения на частоте ВЧ поля = 8 МГц вдоль разрядного промежутка длиной 80 мм в разрядной трубке диаметром 100 мм. Плазмообразующий газ – гелий, давление – 65 Па,
1 – VВЧ =150 В, 2 – VВЧ = 280 В [18].
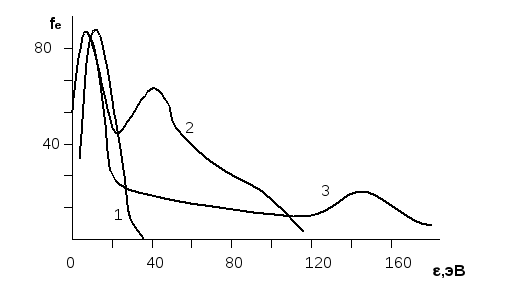
Рис. 1.17. Зависимость ФРЭЭ от величины ВЧ напряжения в центральной области разряда. d = 80 мм, р = 65 Па, = 8 МГц, плазмообразующий газ – гелий. 1 – VВЧ = 200 В,
2 – 400 В, 3 – 600 В [22].
С целью определения полной картины перестройки разряда с изменением частоты и напряжения прикладываемого ВЧ поля рассмотрим зависимость от этих параметров концентрации электронов ne, постоянной составляющей потенциала электрического поля V0 и ФРЭЭ fe(), а также их распределение вдоль разрядного промежутка.
В таблице 1.1. представлены данные о концентрации электронов в центре межэлектродного пространства ne0 для различных режимов горения ВЧ-разряда. Откуда видно, что величина ne0 существенно возрастает с увеличением частоты или напряжения прикладываемого электрического поля. Вместе с тем меняется характер распределения постоянной составляющей потенциала электрического поля V0 (x) вдоль разрядного промежутка (рис. 1.19). Распределение становится в приэлектродной области менее плавным и принимает столообразную форму с одновременным ростом величины V0 в любой точке х от центра плазмы до электрода. Интерпретация описанных зависимостей становится ясной при рассмотрении влияния частоты и величины ВЧ напряжения на вид ФРЭЭ (рис. 1.17 и 1.20). При увеличении какого-либо из этих параметров наблюдается интенсификация генерации быстрых электронов с энергиями существенно превосходящими потенциал ионизации гелия. Вследствие этого интенсифицируются процессы ионизации и растет величина концентрации электронов в какой-либо локальной области разрядной плазмы. Указанное на рисунках изменение функции fe() с увеличением VВЧ при фиксированной частоте и с ростом при фиксированном VВЧ объясняется разогревом электронов в приэлектродном слое в процессе их взаимодействия с пульсирующим потенциальным барьером. Этот разогрев, очевидно, увеличивается с ростом постоянной составляющей барьера, которая в свою очередь увеличивается с ростом ВЧ напряжения. Статистический же разогрев электронов пульсирующей составляющей потенциального барьера растет с увеличением частоты поля, так как увеличивается частоты “ускоряющих” упругих взаимодействий барьера и электронов. В результате процесса разогрева электронов увеличивается падение ВЧ напряжения в приэлектродных слоях, вследствие чего увеличивается постоянная составляющая пульсирующего потенциального барьера, формирующего пучок быстрых электронов в приэлектродных областях.
Таблица 1.1. [18]
Зависимость концентрации электронов в центре разрядного промежутка ne0 от частоты и прикладываемого напряжения VВЧ, d=600 мм, гелий, р = 65 Па.

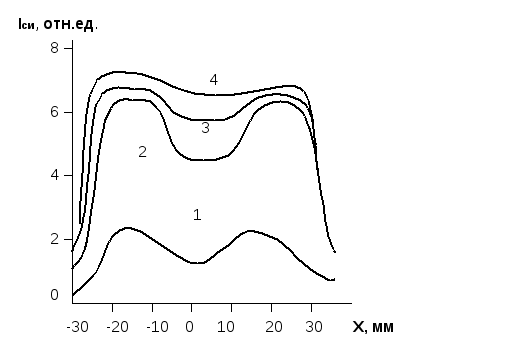
Рис. 1.18. Распределение постоянной составляющей интенсивности интегрального свечения Iси вдоль разрядного промежутка при различных ВЧ напряжениях. Плазмообразующий газ – гелий, р = 65 Па, = 10 МГц. 1 – VВЧ = 40 В, 2 – 120 В, 3 – 160 В, 4 – 200 В. (Кривые построены по
экспериментальным точкам [18]).
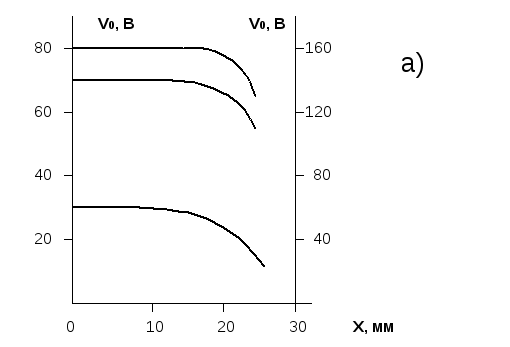
1
2
3
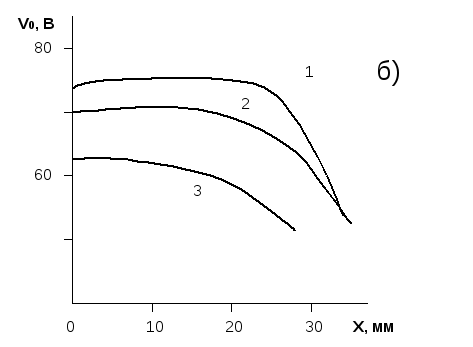
Рис. 1.19. Распределение постоянной составляющей потенциала электрического поля V0(x) вдоль разрядного промежутка от центра к электроду. Плазмообразующий газ – гелий, р = 65 Па.
а) зависимость V0(x) от величины приложенного напряжения VВЧ; = 5 МГц;
1 – VВЧ/ = 300 В (ось ординат справа), 2 – 120 В, 3 – 40 В.
б) зависимость V0(x) от частоты ; VВЧ/ = 120 В;
1 – = 9 МГц, 2 – 5 МГц, 3 – 3 МГц [18].
В силу того, что генерация пучка быстрых электронов происходит в приэлектродной области разрядного промежутка и электроны выталкиваются в плазму в направлении перпендикулярном плоскости электрода наблюдается пространственная анизотропия зондовых характеристик при размещении зондов вблизи электродов [22]. В этом случае, при ориентации плоскости зонда к плоскости электрода (обе плоскости параллельны), зондовая характеристика (зависимость двойного дифференциала тока на зонды по энергии от энергии электронов) имеет существенно большую высокоэнергетическую часть, чем зондовые характеристики при других ориентациях.
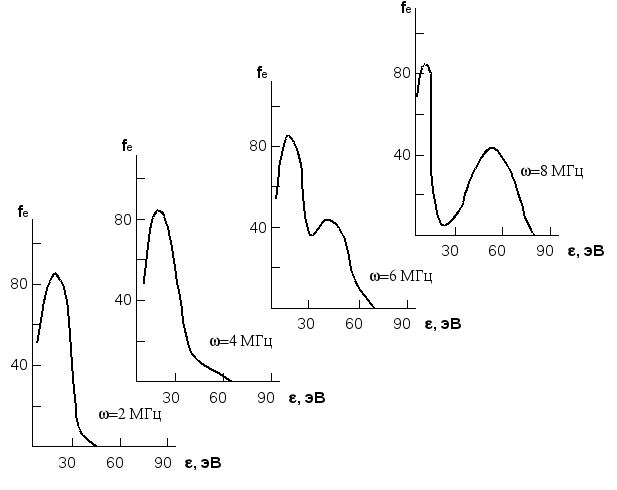
Рис. 1.20. Зависимость f() от при фиксированном ВЧ напряжении VВЧ/ = 300 В. Плазмообразующий газ – гелий, р = 65 Па, d = 200 мм, расстояние зонд-электрод – 60 мм [22].
С удалением зонда от электрода его характеристика становится все более изотропной, вместе с тем уменьшается и доля высокоэнергетичных электронов, а также их энергий [22], что происходит, очевидно, в результате диссипации энергии быстрых электронов и хаотизации их движения при столкновении с тяжелыми частицами плазмы.
Лекция 6
Процессы активации
Взаимодействие частиц, эффективное сечение
Типы взаимодействия частиц: кулоновские, упругие и неупругие. Ближние и дальние кулоновские взаимодействия. Траектории движения частиц.
Вероятности взаимодействия характеризуются так называемыми эффективными сечениями взаимодействия (из кинетической теории газов).
Рассмотрим (рис. 2.1) мишень с однородной плотностью = MN неподвижных частиц, пучок взаимодействующих частиц с концентрацией n и скоростью u.
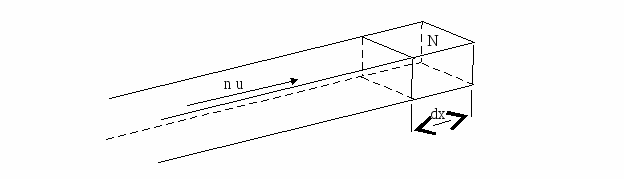
Рис. 2.1. Воображаемое сечение элементарного параллелепипеда единичной площади при взаимодействии частиц.
Число частиц испытывающих взаимодействия пропорционально плотности частиц мишени, плотности частиц самого потока и длине dx, на котором рассматривается взаимодействие
dn = nN dx = nNu dt.
Коэффициент пропорциональности это эффективное сечение данного взаимодействия для отдельной частицы.
Вероятность взаимодействия
Pc = N/p0,
где p0 – приведенное давление (Торр).
p0 = 273 p/T,
где температура T и давление p при данных условиях. Pc – среднее число взаимодействий частицы на расстоянии 1 см при давлении 1 Торр и 0 С.
Длина свободного пробега lср
lср = 1/N = 1/ Pcp0.
Упругие взаимодействия
Кулоновские взаимодействия и рассеяние электронов и ионов на нейтралах.
F = z1z2e2/r2, упр< кулон
Эффект слабого рассеяния электронов при малых энергиях в инертных газах, назван эффектом Рамзауэра (рис. 2.2). Он объясняется чисто квантовыми явлениями – дифракцией электронов на атомах. При больших энергиях применимо классическое рассмотрение, т.к. длина волны электронов становиться много меньше размера атомов.

Рис.2.2. Зависимость сечения рассеяния электронов на различных частицах от скорости электронов.
упр для электронов имеет характерные значения порядка 10–15 см2.
Неупругие взаимодействия
Максимальное изменение потенциальной энергии частицы
(Eпот)max = E1m2/( m1 + m2),
где E1 – кинетическая энергия налетающей частицы. Из формулы видно, что при соударении электрона с тяжелой частицей возможен практически полный переход кинетической энергии в потенциальную, т.е. неупругие столкновения с участием электрона наиболее эффективны.
Возбуждение (тушение) атомных, ионных и молекулярных состояний.
e + Ak0(+) An0(+) +e
Это пороговый процесс, в (Ekn) имеет величину порядка нескольких эВ.
kn 10–16 – 10–19 см2. Максимум при Eкин = (1,5 2) Ekn (рис. 2.3).
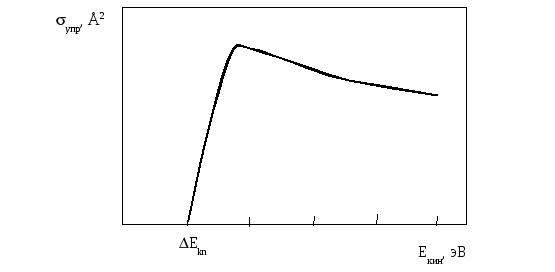
Рис.2.3. Типичный вид зависимости сечения возбуждения атомов электронным ударом от энергии электронов.
Возбуждение (тушение) молекулярных состояний:
e + Mk,i,j0(+) Mk,i,j0(+) +e
Энергетические зазоры между колебательными уровнями 10–2 – 1 эВ, между вращательными уровнями 10–3 – 10–1 эВ. Поэтому медленные электроны эффективно теряют энергию на возбуждение этих уровней.
Для N2 сечение возбуждения колебательных уровней (0,5 3) 10–16 см2.
Диссоциация молекул.
e + M A +B + e
Вероятность прямого разбиения молекулы из основного состояния мала. Причина – кратковременность воздействия, в течение которого атомы (или радикалы) не успевают получить необходимого для разлета количества движения.
Диссоциация молекул часто преимущественно идет ступенчато через электронно-колебательные, электронные и колебательные возбужденные состояния с достаточным временем жизни:
e + M M + e
e + M A + B + e
Обратный процесс – ассоциация.
Зависимость сечения диссоциации молекул электронным ударом от энергии электронов имеет разный вид для различных молекул (рис. 2.4).
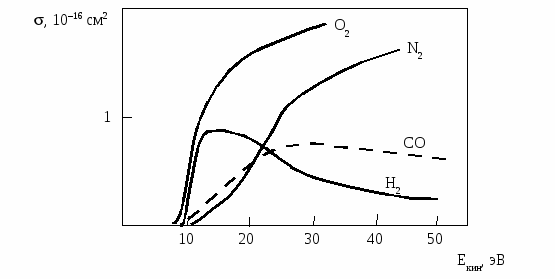
Рис.2.4. Зависимости сечения диссоциации молекул электронным ударом от энергии электронов.
Ионизация атомов и молекул.
e + Ak Ai+ + e + e
Обратный процесс – тройная рекомбинация.
Из основного (k = 1) состояния потенциал ионизации Eи для разных частиц находится в интервале 4 – 25 эВ. Максимум 1 достигается при Eкин = (3 5)Eи, ход зависимости 1(Eкин) для разных атомов и молекул имеет одинаковый вид (рис. 2.5), соответствует аппроксимации Фабри–Канта.
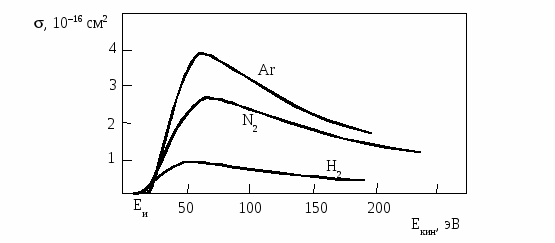
Рис.2.5. Зависимости сечения ионизации атомов и молекул прямым электронным ударом из основного состояния от энергии электронов.
Ионизация из возбужденного состояния называется ступенчатой.
kи(Eкин) = k3 1(Eкин) т.е. kи k3, k – главное квантовое число уровня.
При Te << Eи эффективна ступенчатая ионизация по сравнению с прямой.
Частота ионизации и (характеризует скорость рождения зарядов) т.е. число актов ионизации в 1 см3 в 1 с производимое электроном для газового разряда
и = (5 102 – 103) Гц.
и = na = nakи.
- усредненное по энергетическому спектру. Коэффициент kи – называют константой (или коэффициентом) скорости ионизации, смысл kи следует из выражения:
(dne/dt)и = kиnena.
Аналогичные выражения можно записать для процессов возбуждения и диссоциации. Коэффициент скорости процессов возбуждения, ионизации и диссоциации электронным ударом можно определить так:
 , ,
где A – некоторая постоянная, m – масса электрона, – его энергия, () – сечение процесса, 0 – энергия верхнего уровня при возбуждении или пороговая энергия при ионизации и диссоциации, f() – функция распределения электронов по энергиям.
Для молекул не редко более эффективно проходит диссоциативная ионизация
e + M A+ + B + e + e,
например e + CF4 CF3+ + F + e + e,
Рекомбинация с участием электронов.
Процесс обратный ионизации электронным ударом называется тройной рекомбинацией:
A+ + e + e A + e
М+ + e + e М + e.
Избыточная энергия передается второму электрону или тяжелой частице (в этом случае рекомбинацию называют трехчастичной). Процесс происходит ступенчато:
- захват электрона на далекую орбиту
- переход на нижележащий уровень в результате столкновения с электроном, тяжелой частицей или излучения кванта света.
Трехчастичная рекомбинация может быть при участии нейтральной или ионизованной частицы (атома или молекулы):
A+ + e + B A + B,
A+ + e + B+ A + B+.
Рекомбинация с излучением кванта света называется радиационной рекомбинацией
A+ + e A + h,
h = eи + meue2/2.
Скорость рекомбинации равна
(dne/dt)рек = nenи.= ne2.
Коэффициент скорости рекомбинации пропорционален концентрации третьей частицы. 10–14 – 10–8 см3/с.
Для радиационной рекомбинации коэффициент скорости имеет величину 10–14 – 10–13 см3/с.
Диссоциативная рекомбинация
(AB)+ + e Ak + B
имеет коэффициент скорости порядка 10–8 см3/с. Здесь третья частица образуется в ходе рекомбинации. Обратный процесс называется ассоциативной ионизацией. Вероятность диссоциативной рекомбинации значительно больше, чем тройной, поэтому процесс диссоциативной рекомбинации может быть существенным источником генерации возбужденных атомов и радикалов.
Для газового разряда низкого давления рекомбинация электронов на поверхности во много раз превышает объемную рекомбинацию и определяет скорость гибли электронов.
Образование отрицательных ионов.
Образование отрицательных ионов т.е. процесс прилипания электронов к тяжелым частицам характерен для ряда атомов и молекул (в том числе щелочных металлов и галоидов): F, Cl, Br, I, Li, Na, Ka, O2, H2O, OH, O.
Основная характеристика отрицательных ионов – энергия их связи (энергия сродства) к электрону. Она численно равна энергии необходимой для разрушения иона. Типичные значения сродства E 0,1 – 3 эВ, у галоидов 3 – 5 эВ.
E = E0 – E_ + meVe2 /2.
Механизмы прилипания:
1) e + AB A– + B – диссоциативное прилипание,
1) e + A + B A– + B – трехчастичное прилипание,
1) e + A A– + h - радиационное прилипание.
Разрушаются отрицательные ионы ударами электронов и тяжелых частиц, но определяющим для газоразрядной плазмы являются процессы гибели при реакциях ассоциации:
O– + O O2 + e,
O– + N NO + e,
O2– + O2 O2 + O2 + e,
O– + CO CO2 + e,
H– + H H2 + e,
OH– + O HO2 + e,
OH– + H H2O + e,
F– + F F2 + e.
Процесс убыли отрицательных ионов называется рекомбинацией ионов.
A– + B+ A + Bk
(dnи/dt)рек = (dn–/dt)рек = иn–nи.
и 10–6 - 10–7 см3/с, и и уменьшаются с ростом температуры.
Неупругие столкновения тяжелых частиц
Вероятность неупругого взаимодействия значительна только если относительная скорость частиц примерно равна скорости электрона в атоме (108 см/с), что соответствует энергии тяжелых частиц в 10 – 100 кэВ, поэтому для газоразрядной плазмы низкого давления неупругие взаимодействия тяжелых частиц типа возбуждение, диссоциация и ионизация являются несущественными.
Химические реакции в плазме
Коэффициенты скорости реакций. Реакции ассоциации (присоединения), обменные, замещения, в объеме и на поверхности. Химические реакции в плазме как вторичные процессы активации газоплазменной среды.
Лекция 7
Процессы активации
Процессы взаимодействия частиц плазмы с поверхностью
Взаимодействие атомов, молекул, радикалов и фотонов с поверхностью
Адсорбция и хемосорбция
Под процессом очистки материалов понимают удаление с ее по-верхности инородных атомов и молекул (очистка от инородных час-тиц более крупного размера, например пылинок, здесь не рассматри-вается). Травление – это удаление поверхностных атомов и молекул самого материала. По физико-химическому механизму взаимодейст-вия частиц НГП с поверхностью обрабатываемого материала процес-сы травления можно разделить на три нижеперечисленные группы.
1. Ионное травление (ИТ), при котором поверхностные слои мате-риала удаляются только в результате физического распыления. Рас-пыление производится энергетическими ионами газов, химически не реагирующими с обрабатываемым материалом (обычно ионами инертных газов). Под энергетическими ионами понимают частицы с энергией в диапазоне 0,1–2,0 кэВ. Если поверхность находится в кон-такте с плазмой (т. е. плазма является средой, в которой происходит процесс, и источником ионов, которые его осуществляют), то травле-ние называют ионно-плазменным (ИПТ). Если поверхность не контак-тирует с плазмой, которая используется только как источник ионов, осуществляющих травление, то травление называют ионно-лучевым (ИЛТ). В процессе ИПТ поверхность подвергается также воздействию электронов, излучения и нейтральных частиц. Однако на фоне интен-сивного энергетического воздействия ионов их вклад в стимуляцию процесса распыления пренебрежимо мал (исключение составляют ор-ганические материалы, полимеризующиеся или деполимеризующиеся под действием электронного и фотонного потоков).
2. Плазмохимическое травление (ПХТ), при котором поверхност-ные слои удаляются в результате химических реакций. Химические реакции происходят между химически активными частицами (ХАЧ) и поверхностными атомами с образованием летучих продуктов, поки-дающих поверхность. Если поверхность обрабатываемого материала находится в контакте с плазмой, то травление называют плазменным (ПТ). При ПТ химические реакции стимулируются электронной, ион-ной и фотонной бомбардировкой частицами плазмы. Если же поверх-ность образца не контактирует с плазмой, которая используется толь-ко как источник ХАЧ, то такое травление называют травлением сво-бодными атомами и радикалами или радикальным травлением (РТ). РТ осуществляется без стимуляции электронной и ионной бомбарди-ровки, а в ряде случаев и при отсутствии воздействия излучения.
3. Реактивное ионное или ионно-химическое травление (ИХТ), при котором поверхностные слои материалов удаляются как физическим распылением энергетическими ионами, так и в результате химических реакций между ХАЧ и атомами материала. Если поверхность обраба-тываемого материала находится в контакте с плазмой, то травление называют реактивным ионно-плазменным (РИПТ). При РИПТ на по-верхность воздействует максимальный набор частиц плазмы. При этом процесс физического распыления может как замедляться, так и ускоряться химическими реакциями (ускорение происходит в случае образования летучих соединений). Химические реакции, в свою оче-редь, могут активизироваться ионной, электронной и фотонной бом-бардировкой. Если поверхность образца не контактирует с плазмой, которая используется только как источник энергетических химически активных ионов, то такое травление называют реактивным ионно-лучевым (РИЛТ). В процессе РИЛТ поверхность подвергается воздей-ствию молекулярных или атомарных ионов, которые кроме физиче-ского распыления образуют ХАЧ на поверхности в результате их дис-социации и рекомбинации. Химические реакции между ХАЧ и атома-ми поверхности могут как замедлять, так и ускорять процесс физиче-ского распыления.
Процессы ПТ и РИПТ имеют много общего, так как происходят в плазме химически активных газов и обрабатываемая поверхность бомбардируется одинаковым набором частиц: ионов, свободных ато-мов, радикалов, молекул, электронов и фотонов. В качестве условной границы для разделения этих процессов можно использовать значение энергии ионов Eи, бомбардирующих поверхность. При Eи<100 эВ травление следует считать плазменным, так как при такой низкой энергии ионов физическое распыление не может заметно воздейство-вать на скорость удаления материала. При Eи>100эВ основной вклад в процесс удаления материала могут вносить как химические реакции на поверхности, так и физическое распыление.
ХАРАКТЕРИСТИКИ ПРОЦЕССА ТРАВЛЕНИЯ
Процесс травления с использованием НГП характеризуется сле-дующими параметрами: скорость, селективность, анизотропия, нерав-номерность, загрузочный эффект. Скорость травления vтр определяет-ся толщиной поверхностного слоя материала, удаляемого в единицу времени. Селективность травления – это отношение скоростей трав-ления двух различных материалов в одних и тех же условиях травле-ния S = vтр1/vтр2. Эта характеристика является весьма важной, напри-мер, при травлении через маску, когда для качественного проведения процесса необходимо обеспечивать низкую скорость травления маски при высокой скорости травления поверхности через окно в маске или в процессах травления пленочных покрытий, находящихся на под-ложке из иного материала. Показатель анизотропии травления А оп-ределяется как отношение скоростей травления материала по нормали и по касательной к поверхности или как отношение глубины травле-ния h к боковому подтравливанию l:
А = vтр(0)/vтр(90) = h/l. (5.8)
Этот параметр играет определяющую роль для точного формиро-вания размеров элементов маски и для точной передачи геометриче-ских размеров маски на нижележащие слои подложки. Неравномер-ность травления характеризует различие в скоростях травления участ-ков, расположенных в различных местах на поверхности подложки. Повышение равномерности травления – одна из основных задач тех-нологии ИС, особенно для подложек большого диаметра. Под загру-зочным эффектом понимают влияние количества одновременно обра-батываемых пластин на скорость их травления.
РАБОЧИЕ ГАЗЫ ДЛЯ ПРОЦЕССОВ ТРАВЛЕНИЯ И ОЧИСТКИ
Процесс ионного травления основан на физическом распылении поверхности ионами инертного газа. По этой причине требование к рабочему газу таких процессов сводится в основном к обеспечению их высокой химической чистоты (отсутствие в рабочем газе химически активных частиц, способных образовывать с атомами или молекулами поверхности нелетучие химические соединения). Необходимые ско-рость, анизотропия и равномерность должны обеспечиваться конст-рукцией системы травления, типом и характеристиками разряда или ионного источника.
К рабочим газам, используемым в процессах ПХТ и ИХТ, предъ-являются следующие требования:
• максимальный выход энергетических и химически активных частиц, способных при взаимодействии с материалом поверхно-сти образовывать либо стабильные летучие, либо легко распы-ляемые соединения;
• обеспечение при разложении в плазме газового разряда требуе-мых скоростей, селективности и анизотропии травления;
• отсутствие токсичности и взрывоопасности, коррозионного воз-действия и загрязнения стенок реактора, внутрикамерных уст-ройств и откачных магистралей.
Сжатые газы занимают первое место среди потенциально опасных веществ, используемых в производстве ИС. Водород, например, ха-рактеризуется как огнеопасный и взрывоопасный газ. Аммиак вос-пламеняется в воздухе при концентрации от 16 до 25 %. Безводный фтористый водород HF может вызвать смертельный исход при ожоге всего лишь 2,5 % поверхности тела. Высокотоксичны такие газы, как арсин и фосфин, хлор и его соединения (HCl, CHCl2, BCl3, CClF3, SiH2Cl2 и др.). Помимо газов в плазменной технологии применяются пары токсичных жидкостей: трихлорсилана SiHCl3, тетрахлорида кремния SiCl4, четыреххлористого углерода CCl4 и др.
Применение большого числа рабочих газов, как однокомпонент-ных, так и многокомпонентных, вызвано необходимостью травления широкого ассортимента материалов. Первейшим условием для про-цесса травления химически активными частицами является возмож-ность образования летучих и стабильных при температуре процесса Tп (температуре поверхности материала в процессе травления) продуктов реакции. Термин «летучий» означает, что при Tп продукты реакции испаряются с поверхности материала. При использовании ПХТ или ИХТ соотношение величин Tп и Tкип (температура кипения продуктов реакции) определяет три основных вида процесса травления.
1. Tп<
2. Tп = Tкип. Процесс ПХТ в этом случае возможен. Однако низкая скорость удаления продуктов реакции приводит к тому, что процесс травления ограничен стадией химической реакции. С ростом темпера-туры процесса скорость травления материала должна возрастать. Ионная бомбардировка будет оказывать сильное влияние на скорость травления. В системах ИХТ возможно травление за счет распыления. Например, золото служит стопорным слоем при травлении в плазме CF4 в системах ПХТ, а в системах ИХТ оно может травиться.
3. Tп >>Tкип. Травление материалов в любых системах ПХТ и ИХТ осуществляется в основном за счет химических реакций и скорость травления ограничивается лишь скоростью поступления реагентов к поверхности. Изменение температуры процесса и ионная бомбарди-ровка слабо влияют на скорость травления материала.
В общем случае, если при разложении молекул рабочего газа в плазме не образуются нелетучие частицы (например, углерод, поли-мерные пленки и т. д.), которые могут маскировать обрабатываемую поверхность, то скорость травления материала тем выше, чем ниже температура кипения продуктов реакции. Так в плазме молекулярного фтора кремний травится гораздо быстрее, чем в плазме молекулярного хлора. Если в плазме наряду с ХАЧ образуются нелетучие частицы, то скорость травления материала зависит от соотношения числа этих частиц. Для фторуглеродных рабочих газов (CF4, C2F4, C3F8 и т. д.) с уменьшением отношения F/C снижается скорость травления материа-лов с одновременным повышением селективности травления кисло-родсодержащих соединений относительно бескислородсодержащих.
Лекция 8
Вакуумно-плазменные процессы травления
МЕХАНИЗМ И ХАРАКТЕРИСТИКИ ИОННО-ПЛАЗМЕННОГО
И ИОННО-ЛУЧЕВОГО ТРАВЛЕНИЯ
В основе ИПТ и ИЛТ лежат процессы физического распыления материала поверхности энергетическими ионами инертных газов, бомбардирующими поверхность, т. е. распыление осуществляется за счет упругих столкновений, приводящих к выбиванию атомов из равновесных положений. Выбивание атома из поверхностного слоя материала происходит либо путем прямого столкновения между ионом и атомом поверхности, либо путем передачи поверхностному атому кинетической энергии из глубины материала за счет каскада последовательных столкновений между атомами материала. В первом случае атом материала может покинуть поверхность (распылиться) за единичное столкновение или после небольшого числа упругих столкновений с соседними поверхностными атомами. Во втором случае выбивание из равновесных состояний атомов материала начинается на некоторой ее глубине. Выбитые атомы получают энергию, достаточную для выбивания рядом расположенных вторичных и т. д. атомов, часть которых может достичь поверхности материала и преодолеть поверхностный барьер. Такой механизм физического распыления получил название каскадного механизма.
ИТ материала начинается, когда энергия ионов Eи превысит некоторое значение пороговой энергии распыления (Eпор). Значение Епор слабо зависит от масс сталкивающихся частиц и для широкого круга материалов лежит в диапазоне 10–35 эВ. При Еи < Епор ионы не производят распыление, и при взаимодействии с атомно-чистой поверхностью происходит их отражение, нейтрализация электронами, эмитированными из материала под действием электрического поля ионов, адсорбция с последующей десорбцией. Если на поверхности материала присутствуют адсорбированные инородные частицы и химические соединения, то в результате ионной бомбардировки происходят их десорбция и химические превращения (например, рекомбинация, ассоциация или полимеризация).
На десорбирующем действии ионной бомбардировки основан процесс очистки поверхности материала. Процесс выхода в вакуум адсорбированных атомов отличается от выхода распыленных атомов из объема материала следующим: вылетающая частица всегда выходит из верхнего поверхностного слоя, ее энергия связи отличается от энергии связи атомов в объеме. Если массы атомов адсорбирующего вещества и адсорбента сильно различаются, то возможны большие различия в выходе (распылении) адсорбированных частиц. Десорбция при ионной бомбардировке может осуществляться прямым выбиванием адсорбированного атома падающим ионом, его выбиванием отраженным от поверхности ионом и выбиванием распыленным атомом материала. Для ионной очистки поверхности материалов обычно используются ионы с относительно низкой энергией в диапазоне от 20 до 100 эВ, а для ИТ – от 100 до 1000 эВ. В первом диапазоне удаление поверхностного слоя осуществляется в режиме первичного прямого выбивания, а во втором – как в режиме первичного выбивания, так и в режиме линейных каскадов.
Физическое распыление всегда сопровождается нагревом поверхности, созданием большого числа радиационных дефектов кристаллической структуры типа «атом междоузлия» и «пустой узел», внедрением ионов, вторичной электронной эмиссией и электромагнитным излучением в широком спектре частот, вызванном неупругими столкновениями. Все эти процессы в той или иной мере необходимо учитывать при разработке технологии ИТ материалов. Основная доля энергии ионов (70–85 %) выделяется в материале в виде теплоты, около 10 % ее расходуется на распыление, а оставшаяся часть – на остальные указанные выше процессы. Следует отметить, что при ионной бомбардировке в результате образования радиационных дефектов монокристаллическая поверхность вначале превращается в поликристаллическую, а затем в аморфную. Доза аморфизации монокристаллического кремния ионами аргона с энергией 30 кэВ при температуре мишени 300 К составляет 51014 ион/см2.
Физическое распыление материалов количественно характеризуется коэффициентом распыления (S), который определяется как среднее число атомов, удаляемых с поверхности одним падающим ионом. Так как S – статистическая величина, она может выражаться и дробным числом. Значение S зависит от многих параметров проведения процесса распыления, в частности от энергии ионов, распыляемого материала, угла падения ионов на поверхность, температуры поверхности и чистоты ее обработки, состава и давления газовой среды, в которой проводится процесс распыления.
Наиболее существенно влияет на коэффициент распыления энергия ионов. С ростом Eи от пороговой до 100 эВ происходит экспоненциальное увеличение S от 10-4 до 10-1. При Eи = 100–500 эВ S растет линейно, для Eи >500 эВ рост S замедляется. Максимальное значение S достигается в диапазоне энергий между 10 и 100 кэВ. Дальнейшее повышение Eи приводит к резкому спаду S, так как ионы проникают настолько глубоко, что каскадный механизм распыления уже не обеспечивает выбивание поверхностных атомов. В интервале 300–500 эВ максимальная доля энергии ионов расходуется на процесс распыления материала, т. е. достигается максимальная энергетическая эффективность ионного травления.
Увеличение массы иона приводит к росту S. Хотя ионы Kr и Xe по сравнению с ионами Ar дают больший коэффициент распыления в диапазоне оптимальных энергий 100–1000 эВ, их использование ограничено высокой стоимостью получения чистых газов. При увеличении угла падения ионов на поверхность от 0 до 60–70 (отсчет ведется от нормали к поверхности) наблюдается рост S, причем эта зависимость в первом приближении описывается формулой
S() = S(0)/cos .
Объяснить такое поведение S() можно, исходя из механизма физического распыления. Действительно, S при нормальном падении ионов прямо пропорционален энергии, рассеиваемой в поверхностном слое материала, в пределах которого упругие столкновения с атомами будут приводить к распылению. При угле падения длина пробега ионов, а следовательно, и число столкновений в этом слое будут в 1/cos раз больше. С приближением угла к 90 коэффициент распыления резко падает из-за зеркального отражения ионов от поверхности.
Коэффициент распыления для поликристаллических и аморфных материалов практически не зависит от температуры поверхности в диапазоне от комнатной до 600 К, а для монокристаллических полупроводников – до 400 К. Повышение температуры поверхности выше указанных диапазонов приводит к весьма слабому росту S в основном за счет снижения энергии связи поверхностных атомов под действием тепловых колебаний.
Существенное влияние на коэффициент распыления оказывают активные газы и пары (O2, CO, CO2, N2, H2O, углеводороды), содержащиеся в остаточной среде рабочей камеры после ее откачки вакуумными насосами, а также азот и кислород, попадающие из-за микротечей в рабочей камере и системе подачи газа. Резко снижается коэффициент распыления металлов по причине образования на их поверхности оксидов, нитридов и карбидов. Например, коэффициент распыления Al ионами Ar снижается на порядок при росте парциального давления кислорода от 10-4 до 10-1 Па. Увеличение парциального давления O2 снижает коэффициент распыления SiO2 и Si. Пары воды и CO2, диссоциируя в плазме разряда, выделяют кислород, поэтому их влияние аналогично влиянию чистого кислорода. Присутствие CO приводит к небольшому росту S металлов и SiO2, очевидно, из-за связывания остаточного кислорода с образованием CO2. В то же время присутствие O2, CO2, паров воды приводит к росту коэффициента распыления резистивной маски, следовательно, к ухудшению селективности травления через такую маску.
Процессы ИТ удобно характеризовать величиной скорости травления, которая определяется коэффициентом распыления и плотностью ионного тока jи соотношением
vтр = kjиS, (5.9)
где k – коэффициент пропорциональности, зависящий от атомной массы и плотности распыляемого материала. Очевидно, для достижения максимальных vтр необходимо проводить процесс таким образом, чтобы обеспечить максимальные значения величин jи и S. Современные технологические установки ИПТ материалов обеспечивают скорости травления от долей до единиц нм/с. Наибольшие значения vтр наблюдаются для Pt, Ag, Au, Cu, наименьшие – для Ti, W, V, Cr, нитрида кремния и оксида алюминия. Технологические установки ИЛТ позволяют увеличить скорость травления в среднем в 2–3 раза за счет более высокой энергии ионов. Однако это значительно меньше достигаемых vтр при плазмохимическом и радикальном травлении. В результате слабой зависимости vтр от материала поверхности невозможно получить высокую селективность ИПТ и ИЛТ, конкурирующую с селективностью остальных способов размерной обработки материалов в технологии ИС.
Процессы ИПТ и ИЛТ обладают к тому же рядом ограничений при травлении рельефных поверхностей и травлении через маску. К таким ограничениям относится переосаждение распыляемого материала. Переосаждение происходит из-за того, что каждая элементарная площадка поверхности травления является одновременно и приемной для других эмитирующих площадок, находящихся от нее на линии прямой видимости. В результате некоторые площадки поверхности за время ИТ принимают на себя больше материала, чем удаляется с них. Процесс переосаждения увеличивается с повышением плотности рельефных элементов (ступенек, канавок и т. д.) на подложке. При травлении узких канавок распыленные со дна канавки атомы осаждаются на боковой поверхности, что в итоге приводит к V-образному профилю травления. Кроме этого, осажденный на боковой поверхности маски материал остается после удаления маски. Вторым ограничением является неравномерность травления при использовании масок. Отражение ионов от боковых стенок маски или созданного ранее рельефа приводит к усилению травления поверхности подложки около основания маски или границы рельефа. Третьим ограничением является высокий уровень теплового и радиационного воздействия на обрабатываемые структуры, что приводит к изменению электрофизических и химических свойств диэлектриков, тепловой деформации органических резистивных масок, пробою диэлектрических пленок, образованию подвижного заряда и поверхностных состояний на границе раздела Si/SiO2. Конечно, существуют определенные технологические приемы, позволяющие уменьшить роль указанных ограничений на качество процессов травления, однако полностью их устранить пока не удается.
Основным достоинством процессов ИПТ и ИЛТ является их сравнительно высокая анизотропия. По своему механизму процесс ИПТ должен обладать высокой анизотропией, однако низкая стойкость масок и затрудненный выход распыленного материала из глубоких канавок при используемых рабочих давлениях порядка единиц Па ограничивает показатель анизотропии A в диапазоне 5–10. Что касается процессов ИЛТ, то направленное движение ионов, падающих на обрабатываемый материал перпендикулярно его поверхности, позволяет дос¬тичь величины A>100. Такое значение A реализуется при давлении в рабочей камере p<0,1 Па, когда практически отсутствует рассеивание падающих ионов на распыленных, покидающих поверхность атомах. Высокая анизотропия ИЛТ позволяет переносить рисунки субмикронных размеров, полученные в органических резистивных масках, на слои рабочих материалов, причем при A>100 перенос не сопровождается увеличением переносимых размеров, т. е. разрешение, полученное в маске, полностью воспроизводится в рабочем материале.
Рассматривая процессы ИПТ и ИЛТ с точки зрения их применимости в технологии СБИС, следует отметить следующее. В настоящее время процессы ИПТ в основном используются для очистки поверхностей, реже – для травления планиризированных поверхностей и травления без масок. Процессы ИЛТ благодаря более высокому разрешению, меньшему тепловому и радиационному воздействию на обрабатываемые структуры и отсутствию эффекта обратного осаждения распыленного материала почти полностью вытеснили процессы ИПТ из сферы размерного высокопрецизионного травления функциональных слоев ИС. Разрешение процессов ИЛТ ограничено лишь минимальными размерами элементов, которые можно получить в резистивных масках, а не самим процессом. Кроме этого возможность изменения профиля травления (например, получение наклонных профилей) за счет изменения угла падения ионов и универсальность процесса, позволяющая травить практически любой материал, характеризует ИЛТ как эффективный технологический процесс при изготовлении СБИС.
МЕХАНИЗМ И ХАРАКТЕРИСТИКИ ПЛАЗМОХИМИЧЕСКОГО
И ИОННО-ХИМИЧЕСКОГО ТРАВЛЕНИЯ
Механизмы ПХТ и ИХТ имеют много общего, т. к. основаны на гетерогенных химических реакциях между ХАЧ, образующимися при диссоциации молекул рабочего газа в плазме разряда, и активными центрами обрабатываемого материала, представляющими собой поверхностные атомы со свободными валентностями. Наиболее простой вариант ПХТ – это радикальное травление (РТ). Обрабатываемый материал при РТ находится в зоне, отделенной от плазмы перфорированным металлическим экраном, магнитным полем, расстоянием или другими способами. Такое разделение не позволяет ионам и электронам достигать поверхности материала и в то же время практически не создает преграды для незаряженных частиц ХАЧ.
В механизме РТ можно выделить следующие основные стадии: превращение молекул рабочего газа в ХАЧ в плазме газового разряда; доставка ХАЧ к поверхности материала, подвергаемого травлению; взаимодействие ХАЧ с активными центрами материала, включающее хемосорбцию ХАЧ на поверхности материала, химическую реакцию и последующую десорбцию образующихся летучих продуктов реакции; отвод продуктов реакции из реакционной камеры. Скорость процесса травления в целом определяется скоростью наиболее медленной стадии.
Лекция 9
Процесс плазмохимического удаления фоторезиста
Завершение цикла фотолитографических операций заключается в удалении пленки фоторезиста с поверхности подложки. При выборе метода удаления фоторезиста прежде всего следует исходить: из химического строения, растворимости в определенном круге растворителей, характера прошедших фотохимических или термических процессов, возможности применения механического воздействия и устойчивости материалов подложки к режимам удаления. Для удаления фоторезистов в настоящее время приме-няются различные физико-химические методы.
страница 1 страница 2 страница 3
|