страница 1 | страница 2 страница 3
Химические методы. Основными технологическими приемами удаления фоторезистов являются либо их обработка в соответствующих растворителях, либо комплексная обработка с применением окислителей. Наиболее легко удаляются пленки позитивных фоторезистов обычным растворением в ацетоне, диоксане, диметилформамиде или водно-щелочных растворах. Однако если процессу травления предшествовала достаточная для термолиза температурная обработка, то процесс удаления фоторезистов значи-тельно усложняется и вызывает необходимость применения окислителей либо механического воздействия.
Негативные фоторезисты, структурированные под действием света, не растворяются при обработке растворителями, поэтому их удаление с помощью последних всегда связано с применением механического воздействия. Наиболее широко распространенным методом для негативных фоторезистов является погружение в хлорированные углеводороды при температуре 80–175 °С для набухания, а затем в растворы кислот для ослабления адгезии пленки с подложкой. Окисляющие агенты могут быть использованы также для разрушения пленок фоторезистов, однако их применение весьма ограничено возможной коррозией материалов подложки. Несмотря на многообразие предлагаемых химических средств для удаления фоторезистов, универсальное до настоящего времени не найдено.
Для позитивных фоторезистов, температура сушки которых до травления не превышала 95 °С, предложен метод, заключающийся в предварительном облучении ультрафиолетом для превращения о-нафтохинондиазидов в инденкарбоновые кислоты и последующем удалении (растворении) в слабощелочных растворах. Для пленок, обработанных при температуре до 120 °С, желательна обработка при 50–100 °С.
Плазмохимический метод. В настоящее время широкое распространение получило удаление фоторезистов плаз-мохимическим методом. Этот метод заключается во взаимодействии фоторезиста с атомарным кислородом плазмы, в результате которого образуется двуокись углерода, вода и другие летучие окислы.
Метод плазменного окисления основан на использовании тлеющего разряда в реакционной газовой камере. Поскольку температура электронов намного выше температуры газа, температура всей системы довольно низкая. Основной «возбуждающий» элемент холодной плазмы – атомарный кислород, поэтому окисление органических материалов происходит быстро при температурах примерно 50–100°С. Для полупроводниковой промышленности особенно существенны достоинства этого метода:
-
удаление фоторезиста слабо зависит от его предварительной обработки;
-
реакция происходит при неглубоком вакууме с участием только кислорода, что упрощает удаление примесей из системы.
Вместо кислорода можно использовать водородную плазму, которая удаляет пленки фоторезиста за счет реакции гидрогенизации, и образования газообразных углеводородов метана и этана. Можно также использовать азотно-водородную и аммиачную плазму.
Лекция 10
Процессы размерного травления пленок
Рассмотрим механизм РТ на примере травления кремния при использовании CF4 в качестве рабочего газа. Основной канал образования ХАЧ в плазме – это диссоциация молекулы CF4 электронным ударом как через электронные возбужденные состояния с распадом на нейтральные фрагменты, так и с образованием положительных или отрицательных ионов в результате диссоциативной ионизации или диссоциативного прилипания электронов. В настоящее время установлено, что молекулы CF4 в плазме ВЧ-разряда первоначально распадаются с образованием атомарного фтора, радикалов CF3 и ионов CF3+, CF3- и F-, т. е. могут иметь место все указанные выше каналы диссоциации. Однако более 75 % диссоциирующих молекул CF4 распадается по схеме
CF4 + e CF3 + F + e. (5.10)
Малый вклад диссоциативной ионизации и прилипания, приводящих к образованию CF3+, CF3- и F-, обусловлен относительно низкими значениями средней энергии электронов и степени ионизации плазмы ВЧ-разрядов.
Одновременно с процессом образования ХАЧ наблюдается и обратный процесс (их гибели) – объемная и поверхностная ассоциация, а также химические взаимодействия с обрабатываемой поверхностью. Объемная ассоциация может происходить как при тройных столкновениях
CF3 + F + M CF4 + M, (5.11)
так и через образование возбужденного CF4*
CF3 + F CF4*. (5.12)
В качестве частицы M наиболее вероятно участие молекулы CF4. Образование молекулярного фтора возможно только путем трехчастичной рекомбинации
F + F + M F2 + M, (5.13)
причем вероятность реакции (3.11) значительно выше.
Стационарное состояние концентрации CF4, CF3 и F в плазме разряда устанавливается в результате конкуренции процессов образования и гибели частиц и определяется параметрами разряда (мощность, давление, расход рабочего газа, скорость откачки), площадью и температурой обрабатываемой поверхности, площадью и материалом реакционной камеры, контактирующей с плазмой.
Следующей основной стадией механизма РТ является доставка ХАЧ к поверхности материала. Если характерный размер реактора L много больше длины свободного пробега ХАЧ х, то доставка ХАЧ осуществляется за счет диффузии. Если L << х, то ХАЧ доставляется к поверхности молекулярным потоком. В переходной области L = х для описания процесса доставки ХАЧ может быть использован метод сложения.
Для того чтобы ХАЧ могли достичь поверхности подложки, они должны обладать достаточно большим временем жизни. Экспериментальные исследования зависимости скорости радикального травления от расстояния между подложкой и зоной горения разряда, а также от состава рабочих газов показали следующее. Скорость травления в смеси SF6 + O2 значительно быстрее снижается при удалении подложек от плазменной зоны, чем в смеси CF4+O2, хотя по абсолютному значению скорость в первом случае больше вследствие большего содержания в смеси атомов фтора. Поэтому для получения высоких скоростей РТ целесообразно применять смесь SF6+O2 и располагать подложки ближе к зоне плазмы. Для обработки материалов на значительных (более 130 мм) расстояниях от зоны плазмы выгоднее использовать смесь CF4+O2, так как на таких расстояниях скорости травления становятся сравнимыми со скоростями травления в смеси SF6+O2 и даже превосходят их, а падение скорости меньше, что делает некритичным положение подложки, а следовательно, повышает воспроизводимость травления. Более медленное снижение vтр при удалении подложек от зоны плазмы в смеси CF4+O2 по сравнению с чистым CF4 объясняется образованием радикалов COF, которые имеют значительно большее время жизни, чем атомы фтора. Оптимальное содержание O2 в смеси CF4+O2 в металлических реакторах составляет 30–45 %, при этом достигается одновременно максимум vтр и наименьшее ее падение с удалением подложек. На изменение vтр с удалением подложек от зоны плазмы влияет также материал и размеры реактора. Время жизни атомов фтора в реакторах из нержавеющей стали составляет 3,5 мкс при давлении 26 Па и 150 мкс при давлении 5×10-4 Па.
Большое значение на характер протекания процесса травления оказывает давление и скорость потока рабочего газа, температура поверхности материала и плотность на ней активных центров. Взаимодействие ХАЧ с активными центрами материала включает адсорбцию на активных центрах, химическую реакцию и последующую десорбцию продуктов реакции. При адсорбции молекул рабочего газа (CF4, SF6, CHF3, CCl2F2) они не вступают в реакцию с кремнием. Под действием электронной, ионной и фотонной бомбардировки адсорбированные молекулы могут диссоциировать с образованием радикалов вида CFx и CClx (где х = 1,2,3), углерода, а также атомов F и Cl. То есть процесс адсорбции с последующей диссоциацией молекул рабочего газа является также источником ХАЧ на поверхности. В зависимости от вида и энергии частиц, бомбардирующих поверхность, изменяется скорость диссоциации. Кроме того, бомбардировка ионами с энергией выше порога физического распыления будет приводить к распылению как адсорбированных частиц, так и самого материала и к созданию новых активных центров. Таким образом, вид системы для реализации процессов ПХТ и ИХТ будет сильно влиять на механизм и скорость взаимодействия ХАЧ с поверхностью.
Стадия взаимодействия ХАЧ с активными центрами поверхности монокристаллического кремния заключается в хемосорбции атомов фтора на активном центре. При этом происходит объединение неспаренных электронов в прочную ковалентную связь и ослабевает связь атома кремния с соседними атомами решетки из-за высокой электроотрицательности фтора, который оттягивает на себя электронное облако атома кремния. Последующие адсорбированные атомы фтора превращают такой ослабленный атом в летучее соединение SiF4. В результате удаления с поверхности атома кремния, вошедшего в состав молекулы SiF4, образуются новые активные центры, которые, в свою очередь, вступают в реакцию с атомами фтора по указанному механизму. Таким образом, осуществляется цепная реакция травления кремния. В обобщенном виде она записывается как
Si + 4F SiF4 . (5.14)
Отметим, что реакция (3.14) отражает механизм травления вне области плазмы, когда с поверхности десорбируется только конечный продукт реакции SiF4. При травлении в области плазмы или под воздействием ионной, электронной и фотонной бомбардировки с поверхности кремния могут десорбировать промежуточные соединения типа SiFх (х = 1,2,3), что приводит к активации процесса и в конечном итоге к росту vтр. Активирующее действие ионов и электронов зависит от энергии, с которой они бомбардируют поверхность. Эта энергия, в свою очередь, зависит от потенциала обрабатываемой поверхности относительно плазмы. Если поверхность не заземлена и на нее не подано напряжение, то на поверхности возникает отрицательный «плавающий» потенциал в несколько десятков вольт. Такой потенциал не может обеспечить ионам энергию для эффективного физического распыления поверхности. В то же время энергия ионов, электронов и фотонов оказывается достаточной для активации ПТ. Помимо сказанного положительные ионы ХАЧ сами могут вступать в химическую реакцию и травить материал. Однако в процессах ПТ вклад ионов ХАЧ в vтр мал по сравнению с вкладом нейтральных ХАЧ из-за низкого их содержания в бомбардирующем потоке (не превышает 1 %).
Несколько иная ситуация наблюдается при проведении РИПТ, когда обрабатываемая поверхность находится в контакте с плазмой и размещена на электроде, подключенном к источнику ВЧ-напряжения. В этом случае ионы ХАЧ приобретают энергию, достаточную для эффективного физического распыления. Удаление материала происходит как за счет физического распыления, так и за счет химических реакций между ХАЧ и поверхностными атомами в условиях активирующего воздействия частиц плазмы. При этом физическое распыление активирует поверхность материала, повышая скорость химических реакций, которые, в свою очередь, ослабляют химические связи поверхностных атомов, увеличивая тем самым скорость их физического распыления. Физические и химические процессы РИПТ складываются неаддитивно, т. е. количество материала, удаленного при одновременном протекании обоих процессов, намного больше суммы количества материалов, удаленных с помощью каждого процесса. Соотношение между этими процессами в каждом конкретном случае определяется видом рабочего газа, из которого создаются заряженные и нейтральные ХАЧ, энергией ионов, зависящей от ускоряющего напряжения, и другими факторами.
В процессах РИЛТ обрабатываемый материал находится в вакууме вне зоны плазмы и бомбардируется пучком ускоренных ионов химически активного газа. Причем кинетическая энергия ионов обычно выше, чем для случая РИПТ. Такие ионы в результате перезарядки, диссоциации и нейтрализации в пучке и на поверхности материала могут образовывать ХАЧ и производить травление как путем физического распыления, так и путем химических реакций на поверхности с образованием летучих продуктов. Естественно, скорость травления в этом случае значительно выше, чем для ИЛТ.
Процессы РИЛТ, как и процессы ИЛТ обычно реализуются с помощью автономных ионных источников на основе самостоятельных или несамостоятельных газовых разрядов. Диапазон энергий ионов составляет 300–3000 эВ. Состав ионного пучка определяется продуктами диссоциации рабочего газа. Например, при использовании CF4 была выявлена следующая композиция: 78 % CF3+; 7,8 % CF2+; 4,4 % F+; 3,7 % CF+; 3,1 % C+; 1,9 % CF2+. При бомбардировке кремния таким пучком основной механизм химических реакций на поверхности состоит из адсорбции CF3+ и диссоциативной рекомбинации
(CF3+)адс + e + Si (C)адс + 3(F)адс + Si , (5.15)
причем процессу диссоциации способствует выделяемая при рекомбинации энергия. Образование летучего продукта SiF4 происходит по реакции (3.14), а удаление адсорбированного углерода по реакции:
(С)адс + 4(F)адс CF4. (5.16)
Максимальный вклад поверхностных химических реакций в РИЛТ наблюдается при низких энергиях ионов (меньше 300 эВ). Ионы большей энергии внедряются в приповерхностный слой, производя физическое распыление.
Скорость РТ при одних и тех же параметрах процесса (мощность, давление, расход рабочего газа и др.) всегда меньше скорости ПТ, что связано с рекомбинацией ХАЧ при их доставке к поверхности материала и отсутствием стимуляции. Обычно величина vтр для РТ составляет 1–10 нм/с, а для ПТ – от единиц до нескольких десятков нм/с. Увеличение мощности ВЧ или СВЧ-разрядов, которые используются в процессах ПТ и РТ, приводит к росту vтр. На зависимостях скорости РТ от давления рабочего газа наблюдается максимум, который, как и в случае ПТ, объясняется максимумом скорости генерации ХАЧ. На скорость ПТ и РТ при прочих одинаковых параметрах сильно влияет расход рабочего газа G. Увеличение G сначала приводит к росту vтр вследствие повышения концентрации ХАЧ, доставляемых из плазмы, а затем к ее снижению из-за откачки ХАЧ, не успевших вступить в химическую реакцию с материалом подложки. Такая зависимость vтр от G характерна при подаче газового потока параллельно поверхности пластин. Однако для реакторов с индивидуальной обработкой пластин, когда рабочий газ подается перпендикулярно поверхности пластины, снижения vтр с ростом G не наблюдается.
Если лимитирующей стадией является стадия взаимодействия, то скорость ПТ и РТ определяется скоростью реакции на поверхности и зависит от температуры по закону Аррениуса (vтр линейно растет с падением exp(1/T)). В то же время бомбардировка поверхности заряженными частицами может снизить энергию активации химической реакции на поверхности. Таким образом, при интенсивной ионной бомбардировке может быть преодолен энергетический барьер, препятствующий началу химической реакции, в результате чего скорость травления перестает зависеть от температуры (что наблюдается, например, в процессах ИХТ и РИПТ).
При ПТ и РТ легированных материалов обнаружена зависимость vтр от типа легирующей примеси. Более высокая скорость травления кремния, легированного фосфором, по сравнению с кремнием, легированным бором, объясняется тем, что летучесть PF5 выше, чем BF5.
Площадь обрабатываемой поверхности Fм также влияет на vтр. Когда лимитирующей стадией РТ является стадия доставки ХАЧ к поверхности, например при травлении кремния фторсодержащими ХАЧ, то скорость травления уменьшается с увеличением площади материала. Если же лимитирующей служит стадия химической реакции, например при РТ или ПТ SiO2 фторсодержащими ХАЧ, то vтр практически не зависит от Fм.
Характеристики ПХТ определяются не только типом активного газа, но и добавками к нему, которые, не принимая непосредственного участия в травлении, могут значительно изменить ее скорость. Так, если в смесях, содержащих гелий, vтр кремния изменяется пропорционально содержанию SF6, то в смесях, содержащих аргон, уже при составе SF6/Ar = 1/4 vтр достигает 80 % значения скорости, полученной в чистом SF6. Небольшие добавки кислорода сначала приводят к росту скорости травления, так как кислород удаляет углеродную пленку с поверхности хрома, увеличивает содержание ХАЧ в хлорсодержащей плазме и усиливает химические реакции, в результате которых образуется летучее соединение Cr2O2Cl2. При дальнейшем увеличении содержания кислорода vтр уменьшается пропорционально его концентрации, что связано с сильным разбавлением CCl4, которое уменьшает количество ХАЧ, вызывает окисление хрома с образованием стабильных нелетучих соединений. Особенно сильное влияние оказывает добавка кислорода в плазму CCl4 при ПТ пленок хрома. Без кислорода хром практически не травится (vтр<0,01 нм/с), а по мере увеличения содержания кислорода vтр резко возрастает и достигает максимума около 1 нм/с. Когда содержание кислорода в газовой смеси превышает 40 %, vтр резко снижается.
Сильное влияние газовых добавок на характеристики травления обнаружено для процессов РИПТ. Добавка к CCl4 азота в количестве до 70 %, не снижая скорость и равномерность травления Al, обеспечивает достаточно высокую селективность (до 15 по отношению к SiO2), хорошую анизотропию и полностью устраняет образование полимерных пленок. РИПТ сплава Al–Si–Cu наиболее целесообразно проводить в смеси 50 % CCl4 + 50 % Cl2 при сравнительно низком давлении смеси (до 5 Па) и низкой ВЧ-мощности. В таком режиме помимо химического травления Al и Si одновременно обеспечивается физическое распыление нелетучих продуктов взаимодействия меди и хлора.
Скорость РИПТ большинства материалов в диодных системах сравнительно невелика и составляет от долей до единиц нм/с, что связано в первую очередь с низкой степенью ионизации (около 10-4), характерной для диодных систем при давлении 5–10 Па. Степень ионизации и скорость травления могут быть увеличены как минимум на порядок при использовании разряда магнетронного типа (разряда в скрещенных электрическом и магнитном полях).
Зависимость vтр РИПТ от мощности разряда, давления в реакторе, обрабатываемой площади подобна таким зависимостям для ПХТ.
Самая высокая скорость РИПТ SiO2 (15 нм/с) была получена при индивидуальной обработке пластин в плазме газовой смеси C2F6 + CHF3 + O2. Первый компонент обеспечивал высокую скорость травления, второй – значительную селективность (5:1 для SiO2 относительно кремния и фоторезиста). Добавка кислорода обеспечивала анизотропный профиль травления.
Скорость РИЛТ лимитируется выделяемой на обрабатываемой поверхности мощностью, поскольку стойкость органических резистивных масок снижается при температуре подложки выше 100 120 С. Она в 3–15 раз превосходит скорость ИЛТ, но в 2–3 раза уступает скорости ПХТ. В диапазоне энергии ионов 50–300 эВ скорость РИЛТ значительно возрастает, при более высоких энергиях ее рост замедляется, что объясняется физико-химическими особенностями процесса. Повышение давления рабочего газа также приводит к росту скорости травления, поскольку усиливается роль химического компонента процесса РИЛТ. Существенное влияние на скорость травления оказывает подаваемый в источник ионов активный газ. Так, замена C2F6 на SiF4 и BF3 снижает скорость травления SiO2 в 1,5 и 2 раза соответственно. Максимальные значения скоростей РИЛТ кремния и его соединений (SiO2, Si3N4), равные 6, 18 и 23 нм/с достигнуты при использовании газов SF6, CF4 и C3F6.
Процессы ПХТ и ИХТ позволяют получать максимальную селективность. Путем выбора рабочего газа и параметров процесса можно в широких пределах менять соотношение скоростей травления двух материалов и достичь селективности S до нескольких десятков. Например, в процессах РТ в смеси CF4+O2 селективность S(Si/Si3N4)=10, S(Si/SiO2)=90, а S (Si/фоторезист ФП-383)=150. ПТ позволяет получить селективность, близкую к селективности радикального травления. При травлении кремния в SF6 получено S(Si/SiO2)=80 при минимальной интенсивности ионной бомбардировки, что достигнуто при минимально допустимой ВЧ-мощности. В то же время при травлении SiO2 с использованием смеси C2F6 + H2 vтр Si в 10 раз меньше vтр SiO2.
Селективность РИПТ алюминия по отношению к SiO2, Si3N4, поликремнию и фоторезисту особенно сильно проявляется в плазме SiCl4, достигая значения 90. Селективность РИЛТ в результате существенного вклада в механизм травления химических реакций на порядок выше, чем селективность ИЛТ. Вместе с тем из-за наличия физического взаимодействия селективность РИЛТ в 2–4 раза ниже, чем селективность ПХТ.
РТ и ПТ наименее анизотропны из всех вакуумно-плазменных процессов. В них всегда имеется боковое подтравливание под край защитной маски из-за бокового травления, имеющего место одновременно с вертикальным, и травления, происходящего с момента достижения нижележащего слоя до остановки процесса. Например, показатель анизотропии А при РТ кремния в CF4 и SF6 через фоторезистивные маски не превышает 1,5–3. Увеличение анизотропии процессов РТ и ПТ возможно при снижении рабочего давления в реакционной камере. При этом растет длина свободного пробега ХАЧ, и при небольших размерах окон в маскирующем слое, сравнимых с его толщиной (около 0,5 мкм), вероятность попадания ХАЧ на боковые стенки снижается.
Показатель анизотропии РИПТ в 3–5 раз выше, чем у ПХТ. Для РИПТ в диодной ВЧ-системе А = 10–20, а в системе с магнитным полем при давления меньше 0,1 Па А = 20–100. Присущая РИПТ высокая анизотропия позволяет использовать его в качестве универсального процесса травления Si3N4, Al, поликремния и фосфоросиликатного стекла, т. е. основных материалов, которые применяются при изготовлении полевых транзисторов МДП-типа с элементами субмикронных размеров. Показатель анизотропии РИЛТ выше, чем у РИПТ, и по своему значению (А =10–100) близок к ИЛТ. Высокая анизотропия РИЛТ обусловлена значительным вкладом физического взаимодействия в процесс травления и направленностью ионов перпендикулярно поверхности. Вследствие химического взаимодействия влияние эффекта переосаждения при РИЛТ проявляется гораздо слабее, чем при ИЛТ, поскольку распыляемый материал удаляется в виде газообразных продуктов.
Рассматривая процессы ПХТ и ИХТ с точки зрения их применимости в технологии СБИС, следует отметить следующее. РТ подвергаются в основном материалы, которые образуют стабильные летучие соединения с ХАЧ и не требуют при этом активации реакции травления. Число таких материалов ограничено по сравнению с материалами, обрабатываемыми в других вакуумно-плазменных процессах. В то же время высокая равномерность травления, что особенно важно при обработке подложек с диаметром более 100 мм, низкий уровень радиационного и теплового воздействия при РТ, позволяющий эффективно использовать органические резистивные маски, выдвигают РТ на особое место при изготовлении ИС с МДП-структурами.
ПТ широко используется в тех случаях, когда не требуется высокое разрешение (для снятия и удаления остатков фоторезиста, задубливания фоторезиста с целью улучшения его термостойкости, проявления резистов после их экспонирования). С помощью ПТ производят травление пленок кремния и его соединений, фосфорно- и боросиликатного стекла, углерода, золота, тугоплавких металлов и других. В технологии ИС с размерами элементов менее 2 мкм применение ПТ затруднено.
Удачное сочетание в процессах ИХТ приемлемых для большинства техпроцессов скорости, селективности и анизотропии, а также относительно высокая гибкость варьирования параметров процесса обеспечили их широкое промышленное использование. Основным препятствием, не позволяющим процессам ИХТ полностью доминировать, является относительно высокий уровень радиационных дефектов, вносимых в обрабатываемые структуры. Глубина нарушенного слоя для кремния и SiO2 составляет 10–30 нм. Восстановление кристаллической структуры требует высокотемпературного отжига, что недопустимо для полупроводников групп AIIIBV и AIIBVI, а в структурах на основе кремния отжиг не гарантирует сохранения субмикронных размеров.
Лекция 11
Механизм формирования пленки
Процесс зародышеобразования
Субкритические и критические зародыши
Адсорбированные атомы могут мигрировать по поверхности, сталкиваясь с другими атомами могут объединяться в малые частицы (кластеры) или иначе называемые зародышами. Они, по сравнению с отдельными атомами, должны быть более устойчивы к повторному испарению. В большинстве теорий постулируется, что как только зародыш достигнет определенной критической величины, в среднем, он уже не распадается на отдельные атомы, а растет.
Существуют две основные теории зародышеобразования в тонких пленках, основанные на капиллярной и атомной моделях, которые отличаются в подходе к вычислению энергии образования зародышей. Существует и третья заслуживающая внимания модель, в которой подчеркивается возможность испарения кластеров с подложки. Капиллярная модель предсказывает, что изменение свободной энергии при образовании зародыша имеет максимум, т.е. зародыш по мере роста и прохождения через критический размер имеет минимум устойчивости по отношении к диссоциации в паровую фазу. Максимум свободной энергии получается в результате конкуренции двух параметров: очень большого отношения поверхности к объему в малых зародышах, из-за которого их устойчивость уменьшается и наличия энергии конденсации (энергии связей между атомами), увеличивающей устойчивость зародышей с увеличением их размера (рис. 2.3). Таким образом, зародыши, превысившие критический размер, быстро повышают свою устойчивость с каждым присоединенным атомом, и процесс их разрушения и испарения становиться маловероятным.

Рис. 2.3. Зависимость свободной энергии образования
зародыша от его размера.
По-видимому, наилучшей методикой изучения зародышеобразования является проведение процесса осаждения внутри электронного микроскопа, т.к. это дает возможность непосредственно наблюдать за образованием кластеров и измерять их размеры.
Размер критического зародыша и следовательно зернистость пленки сильно зависят от природы металла, для тугоплавких металлов (с высокой температурой кипения), таких как W, Mo, Ta, Pt и Ni, даже очень маленькие зародыши являются устойчивыми. У металлов с низкой температурой кипения, таких как Cd, Mg, и Zn, зародыши должны стать достаточно большими, прежде чем они станут устойчивыми, их устойчивость с увеличением размера растет очень медленно, диссоциация или повторное испарение при этом остаются вероятными. Критические зародыши должны иметь бóльшие размеры, если поверхностная энергия конденсируемого материала велика, а материала подложки мала.
Чем сильнее связь между адатомами и подложкой, тем меньше критический зародыш и тем больше частота зародышеобразования.
Увеличение температуры подложки приведет к увеличению размера критического зародыша. Кроме того, островковая структура будет сохраняться до бóльших средних толщин, чем те, которые соответствуют низким температурам.
Увеличение скорости осаждения приводит к увеличению скорости зародышеобразования и к образованию более мелких островков. Непрерывная пленка образуется при меньших толщинах. Зависимость слабая и эффект заметен только при изменении скорости на несколько порядков.
Лекция 12
Критические температуры конденсации
Критические температуры
Эпитаксиальный рост пленок
На процесс повторного испарения очевидно определяющим образом влияет температура подложки, если нет других энергетических воздействий на поверхность. В эксперименте соответствующую температуру при которой начинает наблюдаться конденсат называют критической Т0. При Т Т0 среднее время жизни адсорбированного атома настолько велико, что все атомы попадающие на подложку, захватываются устойчивыми зародышами и конденсация с самого начала является полной, т.е. коэффициент прилипания s = 1 даже при времени наблюдения близком к нулю. Поэтому, зависимость массы конденсата от времени с момента начала процесса нанесения пленки будет линейной (рис. 2.4). В эксперименте выявление этой линейности разумеется в сильной степени зависит от чувствительности приборов, используемых для измерения сконденсированного вещества. При Т Т0 в начальный период времени конденсация является неполной, т.е. s 1 и по мере накопления на поверхности зародышей с размером больше критического, усиливается захват атомов и присоединение их к растущим зародышам и конденсация становится полной и рассматриваемые зависимости выходят на линейный участок (рис. 2.4).
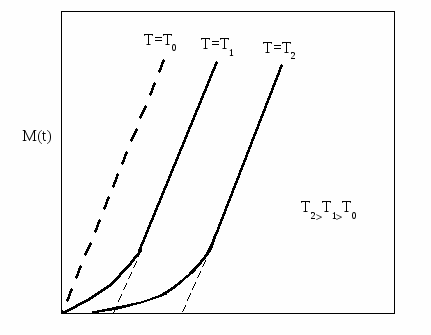
t
Рис. 2.4. Зависимость массы сконденсировавшегося вещества
от времени при разных температурах подложки.
При увеличении температуры подложки степень пересыщения понижается, среднее время жизни адсорбированного атома уменьшается, а коэффициент поверхностной диффузии адатомов увеличивается. Рассмотрение этих эффектов в теориях позволяет определить следующие критические температуры:
- «критическая температура конденсации», выше которой невозможно наблюдать появление осадка, т.к. s 1, ta мало и площадь поверхности, покрытая зародышами и связанными с ними зонами захвата мала; при температуре выше критической конденсацию наблюдать невозможно, при температуре ниже критической она происходит быстро; с критической температурой конденсации связана температура Т0, выше которой конденсация в начальный период времени неполная, а ниже – полная с самого начала;
- температуры «переходов», соответствующие изменению размера критического зародыша, температуры «переходов» можно наблюдать только размер критического зародыша мал и добавление еще одного атома существенно меняет размер зародыша и следовательно его устойчивость;
- температура «эпитаксии», выше которой наблюдается эпитаксиальный рост осадка на монокристаллической подложке; температура «эпитаксии» в сильной степени зависит от скорости осаждения и состояния поверхности подложки.
Лекция 13
Этапы формирования пленки
Четыре этапа формирования пленки по Пэшли.
Механические и электрические свойства пленок в зависимости от условий осаждения
Этапы и четыре стадии формирования пленки
Теория зародышеобразования и электронно-микроскопические наблюдения позволяют выделить последовательность следующих этапов образования зародышей и роста пленки вплоть до образования непрерывной пленки:
-
Появление адсорбированных атомов.
-
Образование субкритических кластеров разного размера.
-
Образование зародышей критического размера (этап зародышеобразования).
-
Рост этих зародышей до сверхкритических размеров с результирующим обеднением адатомами зон захвата вокруг зародышей. Образование критических зародышей на площадях не обедненных адатомами.
-
Зародыши соприкасаются друг с другом и срастаются, с образованием нового островка, занимающего площадь меньше, чем сумма площадей объединившихся зародышей, это приводит к увеличению свободной поверхности подложки.
-
Атомы адсорбируются на этих освободившихся участках, и наступает процесс «вторичного» образования зародышей.
-
Большие островки срастаются, оставляя каналы или полости в пленке.
-
Каналы и полости заполняются в результате вторичного зародышеобразования и в конце концов образуется сплошная пленка.
Основные этапы схематически показаны на рис. 2.5.
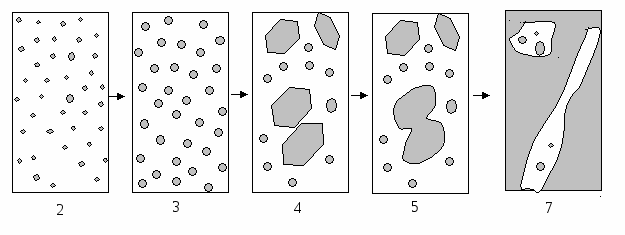   
Рис. 2.5. Этапы формирования пленки.
Можно выделить 4 стадии процесса роста пленки (по Пэшли):
- образование зародышей и островковой структуры (1 – 4 этапы);
- срастание или коалесценция островков (5 и 6 этапы);
- образование каналов (7 этап);
- формирование непрерывной пленки (8 этап).
Образование зародышей и островковой структуры.
Наименьшие зародыши, которые можно заметить в электронный микроскоп имеют размер 20 Å. Зародыши растут в трех измерениях, но рост вдоль поверхности подложки как правило значительно более быстрый чем по нормали. Это обусловлено доминирующей ролью в процессе роста поверхностно диффундирующих адсорбированных атомов в сравнении с ролью атомов приходящих на зародыш непосредственно из паровой фазы. Для Ag или Au, конденсирующихся на подложку MoS2 при 400 С, концентрация первоначальных зародышей составляет 51010 см-2, а минимальная диффузионная длина 500 Å.
Образование каналов.
По мере роста островков степень округления после срастания островков уменьшается. Значительные изменения формы ограничиваются областями в непосредственной близости от места соединения. Поэтому островки вытягиваются и образуют сетчатую структуру, в которой конденсированный материл разделен длинными, узкими каналами неправильной формы, шриной 50 – 200 Å. Зарастание каналов происходит по механизму образования вторичных зародышей, их роста и при прикосновении к стенкам канала образуются мостики, которые быстро разрастаются. В результате образуется пленка со множеством мелких дырок, зарастание которых происходит по аналогичному механизму через образования вторичных зародышей, их срастания, присоединения к пленке, очищение дырки и вновь образования вторичных зародышей и т.д. до полного заполнения дырки.
На стадии роста пленки, характеризующейся образованием каналов и дырок, вторичные зародыши и островки объединяются с массивными областями относительно быстро, менее чем за 0,1 с.
Формирование сплошной пленки
Общий механизм роста поликристаллических слоев похож на механизм роста эпитаксиальных пленок, за исключением того, что срастающиеся островки в этом случае имеют произвольную относительную ориентацию, подчиняющуюся случайному закону распределения. Во время срастания происходит рекристаллизация, поэтому размер зерен растет.
Эпитаксия – это ориентированный или монокристаллический рост пленки. Эпитаксия значительно представлена в технологии микроэлектроники и имеет две основные разновидности:
- автоэпитаксия, ориентированный или монокристаллический рост материала на подложке из того же материала;
- гетероэпитаксия, это ориентированный или монокристаллический рост материала на подложке из другого материала.
Эпитаксиальное выращивание весьма сложный и многофакторно обусловленный процесс. Основные условия, как следует из теоретических и экспериментальных исследований, следующие:
- высокая температура подложки – малые температуры подложки уменьшают отношение скорости эпитаксиального зарождения к скорости неориентированного роста; увеличение температуры активирует процесс осаждения атомов в позициях, сопряженных с кристаллической решеткой подложки, приводит к увеличению поверхностной и объемной диффузии, способствующих сглаживанию несоответствия, которые возникают при росте соседних зародышей; величина температуры эпитаксии зависит от многих параметров критичных для механизма формирования пленки;
- низкие пересыщения – при низких пересыщениях только отдельные места могут действовать как центры зарождения, тогда как при высоких пересыщениях вероятно более беспорядочное, случайное зарождение.
Образование дефектов в процессе роста пленок
Дислокации и дефекты упаковки.
Дислокации и дефекты упаковки вакансионного и междоузельного типов являются наиболее часто встречающимися дефектами в поликристаллических и монокристаллических пленках. Плотность дислокаций обычно составляет 1010 - 1011 см-2.
Основные механизмы появления дислокаций:
1) при сращивании двух островков с кристаллическими решетками, слегка повернутыми относительно друг друга, образуется субграница, состоящая из дислокаий;
2) т.к. подложка и пленка обычно имеют разные параметры решетки, это приводит к смещению атомов пленки и подложки друг относительно друга, разным в разных островках, что может привести к образованию дислокаций при срастании островков;
3) напряжения в пленках могут привести к возникновению дислокаций на краях дырок и границе с подложкой;
4) дислокации, оканчивающиеся на поверхности подложки, могут продолжаться в пленку;
5) при коалесценции островков с дефектами упаковки.
Если измерять плотность дислокаций в процессе роста, окажется, что большинство дислокаций вводиться в пленку на стадии образования каналов и дырок (рис. 2.8). Большинство дислокаций на этой стадии роста появляется из-за несоответствия решеток пленки и подложки и вероятно возникающими напряжениями и соответствующими упругими деформациями.
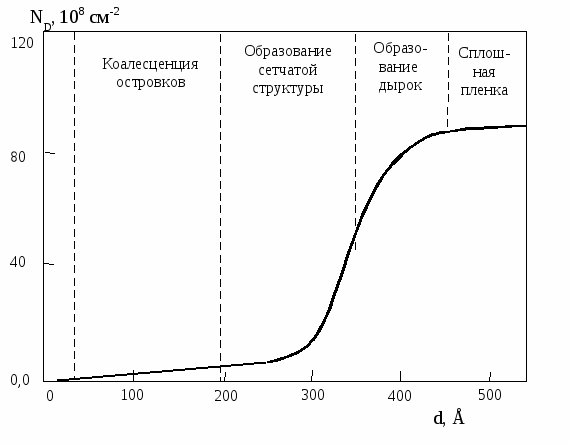
Рис.2.8. Качественная зависимость плотности дислокаций от толщины пленок золота, осажденных на подложке MoS2 при 300 С.
Вакансии могут возникать по разным причинам, в том числе и из-за замуровывания при быстрой конденсации.
Примеси очевидно определяются технологической чистотой процесса.
Природа междоузельных дефектов не менее многофакторна, чем и природа вакансий.
Границы зерен.
В общем случае, в тонких пленках границы зерен занимают большую площадь, чем в массивных образцах материала, т.к. средний размер зерна в пленках меньше. Размер зерна зависит от условий осаждения и температуры отжига (рис. 2.9).
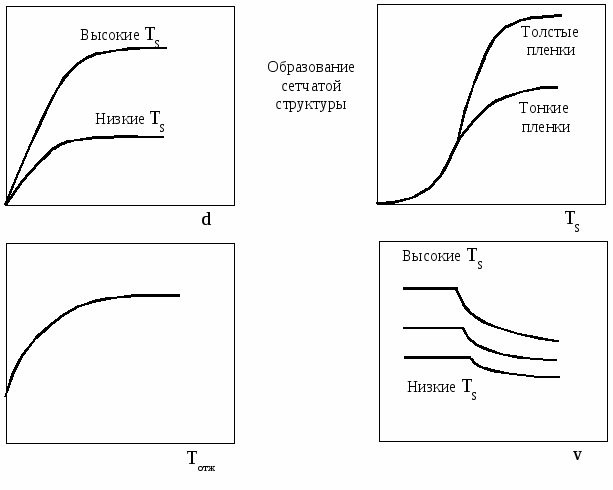
Р ис.2.9. Зависимость размера кристаллитов от толщины пленки d, температуры подложки TS, температуры отжига Tотж и скорости осаждения v. ис.2.9. Зависимость размера кристаллитов от толщины пленки d, температуры подложки TS, температуры отжига Tотж и скорости осаждения v.
Как видно из представленных зависимостей, зерна перестают расти при достижении некоторых значений параметров осаждения. Зависимость размера кристаллитов от толщины пленки свидетельствует о том, что после достижения определенной толщины, новые зерна будут зарождаться поверх старых. Размер зерна увеличивается при увеличении температуры подложки или температуры отжига, т.к. пи этом увеличивается поверхностная подвижность; в результате происходит уменьшение полной энергии пленки за счет уменьшения площади границ между зернами. Зависимость размера кристаллитов от скорости осаждения объясняется тем, что при больших скоростях конденсации затрудняется процесс поверхностной миграции атомов (основного механизма роста зерен), т.е. происходит некоторый эффект «замуровывания».
Площадь поверхности и шероховатость.
В пленке достигается минимум полной энергии в том случае, если площадь ее поверхности поддерживается минимально возможной, т.е. если поверхность представляет собой идеальную плоскость. На практике, в силу известного «островкового» механизма роста, поверхность всегда имеет некоторую шероховатость. Процесс миграции по поверхности частиц очевидно способствует некоторому сглаживанию поверхности.
Экспериментально наблюдалось, что наибольшая площадь поверхности, измеренная с помощью адсорбции газа, получается при нанесении пленки в условиях низкой поверхностной подвижности атомов, т.е. при низких температурах подложки. Показано, что в этих условиях площадь поверхности увеличивается с толщиной пленки линейно и отношение площади поверхности к геометрической площади может быть больше 100 (рис. 2.10).
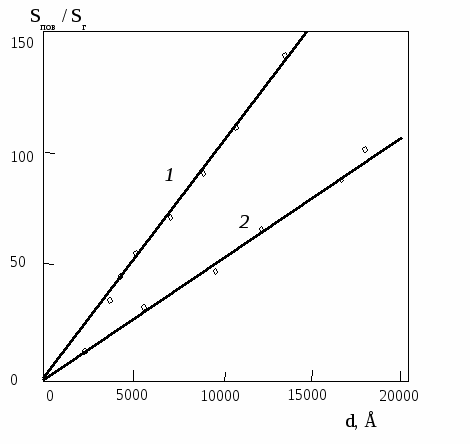
Рис.2.10. Зависимость отношения площади поверхности к геометрической площади от толщины пленки никеля при их нанесении на подложку с температурой около 25 С; 1 – нанесение в атмосфере азота при давлении 1 Торр, 2 – нанесение в высоком вакууме.
Линейное увеличение площади поверхности с толщиной пленки означает, что пленка пористая и адсорбируемый газ может проникать даже в самые нижние слои. Зависимость 1 (осаждение в атмосфере азота) значительно более сильная, ее можно объяснить возникновением конденсата пара у поверхности, т.е. образование мелких частиц (кластеров) упаковка которых на поверхности приводит к образованию более пористой структуры.
Адгезия.
Одним из основных факторов, определяющих долговечность и надежность покрытия, является адгезия, т.е. сила связи с подложкой.
Простой и эффективный метод определения величины адгезии заключается в наложении на поверхность пленки специальной испытательной липкой ленты для последующего исследования процесса отрыва. При слабой адгезии лента отрывается от подложки вместе с пленкой, при сильной – пленка остается полностью на подложке. Для количественной оценки адгезии применяют метод липкой ленты и метод царапания иглой под определенной нагрузкой, методы имеет ряд методических сложностей.
Величина адгезии очевидно определяется природой связи частиц пленки и подложки. Физическая адсорбция определяет слабую адгезию, хемосорбция – сильную. Активные по отношению к кислороду металлы образуют химические связи с подложками, например со стеклом, что приводит к повышению адгезии (рис 3.1).
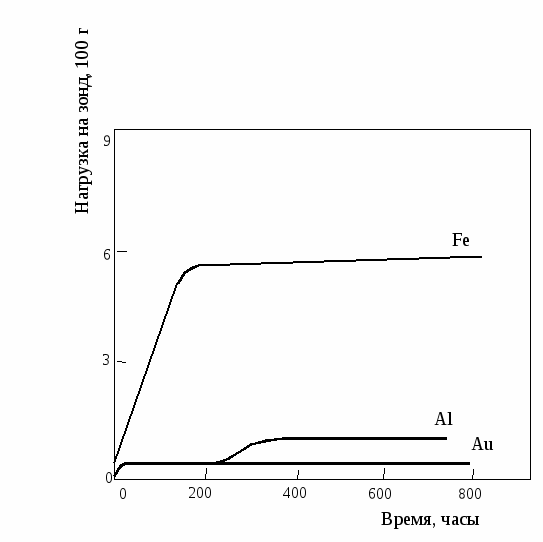
Рис.3.1. Изменение адгезии во времени для пленок золота, алюминия и железа, напыленных на стекло.
Для повышения адгезии нередко специально наносят подслои окисла, современные технологии позволяют также осуществлять плавный переход состава пленки от окисла до чистого металла, что может обеспечить максимальную адгезию.
Электрические свойства пленок, зависимость удельного сопротивления металлических проводников
В соответствии с современной квантовой теорией проводимость в металлах определяется электронами, а электрическое сопротивление обусловлено рассеянием электронов при взаимодействии с решеткой. Из-за своей волновой природы электроны могут проходить сквозь совершенную решетку без затухания, поэтому удельное сопротивление является мерой совершенства структуры кристаллической решетки. В реальности, по ряду причин совершенной структуры не бывает, поэтому электроны подвергаются рассеянию, среднее расстояние, которое электроны проходят между соударениями, называется средним свободным пробегом. Даже если решетка не имеет структурных дефектов, но вследствие тепловых колебаний атомов около своих средних положений решетка не будет совершенной для дрейфа электронов. Электроны будут взаимодействовать с различными видами колебаний решетки (фононами), что и будет определять электросопротивление.
Из теории следует, что при низких значения температуры T << , где
– дебаевская температура определяется выражением = hмакс / k (h – постоянная Планка, k – постоянная Больцмана, макс – максимальная частота колебаний решетки, соответствующая минимальному значению длины волны порядка межатомного расстояния), удельное сопротивление изменяется как Tn (n 5), тогда как при высоких температурах (T >> ) удельное сопротивление от T изменяется линейно.
Для многих металлов дебаевская температура примерно равна комнатной температуре или несколько ниже ее, поэтому при T > 25 С температурная зависимость удельного сопротивления будет приблизительно линейной, что позволяет измерить ТКС (температурный коэффициент сопротивления) .
= R / RT.
Влияние точечных дефектов.
Атом примеси или вакансия как правило имеют эффективный электрический заряд существенно отличающийся от основного заряда металла, поэтому он будет служить дополнительным источником рассеяния электронов. Удельное сопротивление повышается с увеличением концентрации примесей и достигает максимума при 50 % концентрации
(рис. 3.3).
В массивных материалах повышение удельного сопротивления, обусловленное растворенными примесями не превышает 10-кратного значения.

Рис. 3.3. Зависимость удельного сопротивления от компонентного состава сплава серебро – золото.
В пленках в процессе формирования может остаться значительно большее количество примесей, чем будет захвачено в равновесном состоянии. Поэтому можно часто наблюдать увеличение удельного сопротивления в несколько сотен раз. Кроме того, высокие значения удельного сопротивления пленок, могут быть обусловлены образованием изолирующей фазы (например окисла), которая беспорядочно распределяется по всей пленке из-за плохой вакуумной гигиены. На рис. 3.4. показан пример перехода примеси из растворенной в изолирующую фазу и влияния последней на удельное сопротивление.

Рис. 3.4. Зависимость удельного сопротивления тантала от содержания примесного кислорода.
Дефекты структуры (дислокации и границы зерен) мало влияют на удельное сопротивление в сравнении с влиянием вакансий и дефектов внедрения. Исключение составляет случай образования изолирующей фазы по границам зерен.
Отрицательный ТКС в диспергированных пленках.
ТКС очень тонких пленок редко приближается к объемному значению, чаще такие пленки обладают большим отрицательным ТКС. Особый механизм проводимости очень тонких диспергированных (островковых, зернистых по структуре) пленок очевидно определяется их строением. На рис. 3.5 показаны кривые зависимости сопротивления от температуры для прерывистых пленок трех металлов. Имеет место хорошее соответствие этих экспериментальных данных выражению для сопротивления пленок
R = A0 T–e / kT,
где A0, и – постоянные отдельной пленки.
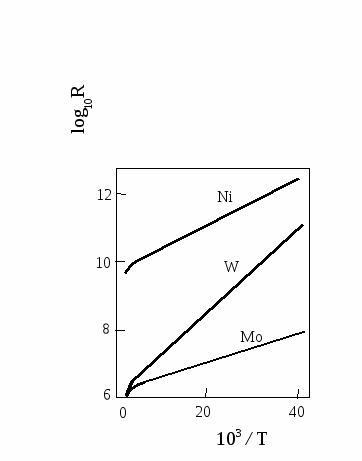
Рис. 3.5. Зависимость сопротивления от температуры прерывистых пленок трех металлов.
Объяснение можно найти рассматривая особую термоэлектронную эмиссию из зерен пленки. Поскольку энергия активации для проводимости диспергированных пленок намного меньше работы выхода соответствующих металлов в массивном состоянии, для объяснения результатов экспериментов следует предположить, что, во-первых, этот более низкий барьер активации обусловлен наложением друг на друга поляризационных силовых потенциалов двух островков, во-вторых, маленькая частичка обладает более низкой работой выхода, чем массив, в-третьих, что форма небольшой частички обуславливает пониженную работу выхода. Если электроны инжектируются в подложку, то необходимо рассматривать только разницу между работой выхода металла и электронов в изоляторе. Таким образом, перенос зарядов посредством термоэлектронной эмиссии вполне может объяснять представленные результаты. Обоснованным объяснением представляется также теория туннелирования, т.е. перенос зарядов посредством туннелирования между разрешенными состояниями.
Лекция 14
Вакуумно-плазменные процессы нанесения тонкопленочных покрытий, их механизмы, характеристики и перспективы развития
Ионно-плазменные процессы
Плазмохимические процессы
Плазмохимическое осаждение
Технология плазмохимического осаждения (ПХО) была создана как развитие технологии химического осаждения из парогазовой фазы, в первую очередь, с целью снижения температуры подложки в процессе формирования пленок. В отличие от химического осаждения из парогазовой фазы при ПХО химические реакции инициируются и стимулируются не посредством высоких температур подложки и газовой смеси, а посредством перевода этой смеси в плазменное состояние в разрядах на постоянном токе, ВЧ- и СВЧ-разрядах, которые характеризуются низкой температурой тяжелых частиц, следовательно, низкой температурой подложки (от комнатной до 400 C) и высокой температурой электронов. Снижение температуры подложки позволяет осаждать пленки на любые ранее созданные структуры и устраняет возникновение внутренних механических напряжений в пленках при последующем охлаждении пластин. Относительно высокое давление в реакционных камерах процесса ПХО (от десятков до сотен Па) не снимает присущего химическому осаждению преимущества – комфорность покрытия. В связи с тем, что технология ПХО основана на химических реакциях, ее часто называют «стимулированное плазмой химическое осаждение».
Механизмы образования плазмы, применяемой в процессах ПХО, подобны механизмам плазмохимического травления. Качественное описание образования пленок при стимулированном плазмой осаждении может быть сведено к трем основным стадиям: генерации в разряде радикалов и ионов, их адсорбции на поверхности пленки, перегруппировке поверхностных адсорбированных или присоединенных атомов, включающей диффузию (миграцию) по поверхности, взаимодействие с другими адсорбированными частицами и образование новых связей. Диффузия адсорбированного атома по поверхности к стабильному положению представляет собой важную стадию роста пленки. Одновременно с образованием пленки должна происходить и десорбция продуктов реакции с поверхности. Скорости десорбции и диффузии сильно зависят от температуры подложки, при большей температуре получаются пленки с меньшей концентрацией захваченных продуктов реакции, большей плотностью и более однородным составом. Кроме этого процессы десорбции могут стимулироваться ионной, электронной и фотонной бомбардировкой. Активация процессов формирования и роста пленки бомбардировкой подложки ионами, электронами, возбужденными частицами и фотонами позволяет путем управления потоками и энергией активирующих частиц расширить возможности управления свойствами пленок и контакта пленка – подложка. Дополнительное достоинство активации плазмой химических реакций состоит в значительном увеличении скорости осаждения и создания пленок уникального состава. ПХО позволяет получать пленки большого числа неорганических и органических соединений. Технология СБИС ПХО нашла применение для формирования пленок переходных металлов и их силицидов, а также нитрида и двуокиси кремния.
Поскольку в реакторах с тлеющим разрядом в зависимости от применяемых газов и условий процесса может происходить как травление, так и осаждение, основные компоненты установок ПХО (за исключением конструкции электродов) подобны используемым в системах травления. Рассмотрим особенности ПХО на ряде примеров.
1. Осаждение пленок W и Mo. Чистый WF6 непригоден для использования в стимулированных плазмой процессах осаждения W из-за того, что при температуре подложки выше 90 C преобладает травление, а не осаждение слоя. Действительно, в результате соударения с электроном генерируются атомы фтора и непредельные фториды вольфрама:
e + WF6  WF6-x + xF + e. (5.10) WF6-x + xF + e. (5.10)
Если атомы фтора не удаляются из зоны реакции или не связываются какими-либо реакциями, то происходит травление вольфрама.
Введение водорода подавляет травление пленки вследствие взаимодействия водорода с фтором, которое может протекать несколькими путями. Например, атомы водорода, полученные в результате диссоциации молекул при столкновении с электронами, могут реагировать с атомами фтора следующим образом:
H + F  HF. (5.11) HF. (5.11)
Молекулярный водород может связывать атомы фтора:
H2 + F  HF + H. (5.12) HF + H. (5.12)
Наконец, водород может переводить WF6 и его непредельные фториды, находящиеся в газовой фазе или на поверхности подложки, во фториды меньшей валентности:
WFx + H  WFx-1 + HF, (5.13) WFx-1 + HF, (5.13)
где x меняется от 1 до 6. Добавление водорода позволяет использовать повышенную температуру подложки, что обеспечивает получение гладких пленок вольфрама без сквозных проколов. Однако скорость осаждения уменьшается при увеличении концентрации водорода в плазме вследствие разбавления вольфрамосодержащего реагента. В диапазоне температур 200–400 С и отношении расходов H2/WF6, равном 3, скорость осаждения вольфрама подчиняется закону Аррениуса, т. е. пропорциональна exp(–1/T) и составляет 4–6 нм/мин.
Диссоциация WF6 с образованием атомов F создает ограничения в использовании ПХО вольфрама в технологии СБИС в тех случаях, когда осаждение W проводится на кремний или его оксид, т. е. на материал, взаимодействующий с фтором. Из этого следует, что на первых этапах ПХО (до образования первых монослоев вольфрама) может произойти заметное подтравливание в плазме участков кремния или его оксида.
Осаждаемые при ПХО пленки W обладают высокой степенью чистоты, имеют столбчатую структуру, что совпадает со структурой пленок, полученных другими методами. Образование столбчатых зерен происходит при росте пленки как на аморфной (термический оксид кремния), так и на кристаллической (сапфир) подложке. Удельное сопротивление пленок вольфрама зависит от температуры подложки и отношения H2/WF6, уменьшаясь с ростом того и другого. Это связано с увеличением размера зерен при повышении температуры и уменьшением захвата фтора растущей пленкой соответственно. Однако практически для всех условий осаждения кратковременная термообработка пленок при температуре 900 С приводит к снижению удельного сопротивления пленок до 8 мкОмсм, что близко к сопротивлению массивного вольфрама.
Пленки молибдена осаждают из смеси гексафторида или пентахлорида молибдена (MoF6 или MoCl5) с водородом. Чистота пленок и, как следствие, их удельное сопротивление сильно зависят от применяемого газа. Продукты диссоциации MoF6 под действием электронов подобны получаемым из WF6.
2. Осаждение силицидов. При ПХО силициды вольфрама (WxSi1-x) осаждают из смеси WF6 и SiH4. Поскольку в разряде присутствует водород, необходимый для связывания фтора, осаждение пленки превалирует над травлением. Скорость осаждения превышает 50 нм/мин, что на порядок выше скорости осаждения вольфрама. Такое ускорение процесса при использовании разряда может быть связано с усилением зародышеобразования в присутствии кремния на поверхности пленки. Изменение отношения расходов WF6/SiH4 изменяет соотношение элементов в осаждаемой пленке от W0,04Si0,96 до W0,99Si0,01, что позволяет в широких пределах менять удельное сопротивление силицида от сопротивления, близкого к сопротивлению поликремния, до сопротивления, близкого к плазмохимическому W.
Как и в случае пленок W сопротивление пленок WxSi1-x снижается при последующих за осаждением термообработках в среде азота, что, по-видимому, связано с выделением из пленки захваченных в процессе роста водорода и фтора.
3. Осаждение нитрида кремния. С этой целью обычно используются исходные реагенты в виде силана и аммиака или азота, и реакция в обобщенном виде выглядит так:
SiH4 + NH3 (или N2)  SixNyHz + H2. (5.14) SixNyHz + H2. (5.14)
В таких процессах обычно получают пленки нестехиометрического состава (отношение x/y не равно 3/4), что может являться достоинством или недостатком в зависимости от предполагаемого применения. Стехиометрические пленки образуются при повышенных значениях мощности, температуры и отношения NH3/SiH4. Когда в качестве источника азота используется N2, то из-за его значительно меньшей скорости диссоциации по сравнению с SiH4 нужен большой избыток азота (N2/SiH4>102), чтобы избежать образования обогащенной кремнием пленки. Аммиак, напротив, может диссоциировать многоступенчато с потреблением малой энергии, что обеспечивает рост пленки активным азотом. Поэтому отношение NH3/SiH4 существенно ниже и находится в диапазоне 5–20. Скорость осаждения возрастает с увеличением мощности разряда и составляет 10–20 нм/мин.
В пленках нитрида кремния, полученных в процессах ПХО, обнаружено большое количество водорода в виде связи Si – H и N – H. По этой причине в реакции нитрид кремния записан как SixNyHz. Общее количество связанного водорода изменяется в зависимости от температуры осаждения и составляет 18–22 ат % в диапазоне температур 380–275 С при осаждении из смеси силан – аммиак. При использовании азота содержание водорода в 1,5–2 раза меньше. Наличие связанного водорода приводит к отличию свойств пленки от свойств осажденного из парогазовой фазы нитрида кремния, а именно, обнаружено небольшое снижение плотности, напряжения электрического пробоя и удельного сопротивления.
4. Осаждение диоксида кремния. В этом случае используются силан и закись азота или кислород:
SiH4 + 2N2O  SiO2 + 2N2 + 2H2. (5.15) SiO2 + 2N2 + 2H2. (5.15)
В таких процессах в пленках SiO2 обнаружены связанные водород и азот – 5–10 ат % и 2–4 ат % соответственно. Отклонение от стехиометричности пленок мало (отношение концентрации O к Si не ниже 1,91). Стехиометрический состав и показатель преломления 1,46, равный его величине для термического диоксида, получены в плазме смеси силана с кислородом при низкой температуре осаждения и малой мощности разряда. Скорость осаждения диоксида кремния в процессах ПХО составляет 15–40 нм/мин.
Ионно-плазменное нанесение покрытий
Технология ионно-плазменного нанесения (ИПН) основана на процессе физического распыления поверхности материала (мишени), из которого необходимо создать пленку, ионами инертного газа, генерируемыми в контактирующей с распыляемым материалом низкотемпературной газоразрядной плазме. Поток распыленных частиц осаждается на приемную подложку, формируя пленочное покрытие. Процесс образования и роста пленки сопровождается бомбардировкой подложки атомами и ионами инертного газа, а также электронами и фотонами, т. е. стимулируется плазменным разрядом. Если плазма создана в смеси инертного и химически активного (реактивного) газов, то технологию называют реактивным ионно-плазменным нанесением (РИПН). В этом случае подложку кроме распыленных частиц и частиц инертного газа бомбардируют химически активные частицы (ХАЧ) или же ХАЧ образуются на самой подложке при диссоциации адсорбированных молекул реактивного газа под стимулирующим воздействием плазмы. Такие условия процесса приводят к формированию пленок химических соединений: оксидов, нитридов и карбидов материала мишени.
Простейшим устройством для реализации технологии ИПН является диодная система с тлеющим разрядом на постоянном токе. Распыляемым материалом является материал катода. Подложки могут быть расположены как на аноде, так и на боковых стенках разрядной камеры.
Физические процессы, сопровождающие ИПН, можно разделить на три группы: процессы распыления поверхности мишени, процессы переноса распыленного материала к поверхности подложки и процессы формирования пленки на подложке. Рассмотрим эти процессы и их влияние на свойства осаждаемых покрытий.
Распыление мишени.
Первоначально в технологии ИПН и РИПН были распространены диодные системы на постоянном токе для распыления металлов и полупроводников, а также на ВЧ-токе для распыления диэлектрических мишеней. Широкое промышленное внедрение таких систем ограничивалось низкими скоростями распыления и, следовательно, малыми скоростями осаждения 0,2–2 нм/с, высоким напряжением горения разряда 2–5 кВ и высоким рабочим давлением 1–10 Па, что снижало производительность технологии и препятствовало получению пленок с минимальным уровнем загрязнений и радиационных дефектов. Положение коренным образом изменилось после появления магнетронных распылительных систем (МРС) – диодных систем, в которых у поверхности мишени создавалось магнитное поле, перпендикулярное электрическому. Взаимодействие полей в сочетании с формой распыляемой поверхности создает такую конфигурацию магнитных ловушек для электронов, при которой токи дрейфа электронов замыкаются на себя. Это обеспечивает высокую степень ионизации газа в МРС, т.е. высокую плотность ионного потока на мишень и, как следствие, повышение vр не менее чем на порядок, снижение напряжения горения разряда до 0,3–0,8 кВ и давления до 0,1–1 Па, что увеличило чистоту наносимой пленки и снизило радиационные повреждения подложки и пленки.
Главным фактором, ограничивающим vр, является максимальный поток мощности, который может быть подан на мишень, не вызывая ее плавления, растрескивания или сублимации. Для металлов с хорошей теплопроводностью допустимая плотность мощности определяется возможностями водяного охлаждения мишени и может составлять до сотен Вт/см2, что соответствует скорости распыления 1–5 мкм/мин.
В отличие от процесса термического нанесения, при котором средняя энергия испаренных частиц составляет доли эВ, средняя энергия распыленных частиц Eр лежит в диапазоне 10–90 эВ, основная часть этих частиц имеет энергию 3–15 эВ. В энергетическом спектре распыленных частиц наблюдается также высокоэнергетический хвост в сотни эВ, однако количество таких частиц относительно мало и не превышает одного процента. Для используемых обычно мишеней из поликристаллических материалов угловое распределение распыленных атомов при напряжениях, близких к 1 кВ, в первом приближении описывается законом косинуса. При снижении напряжения до 0,4–0,5 кВ наблюдается «подкосинусное» распределение распыленных атомов, когда большее число частиц распыляется параллельно поверхности мишени и меньшее – перпендикулярно. Скорость распыления возрастает с увеличением мощности разряда и имеет максимум в зависимости от давления инертного газа. Максимум vр достигается при давлениях 0,5–0,8 Па. Рост vр с изменением давления от 0,1 до 0,5 Па обусловлен ростом плотности ионного потока на поверхность мишени. Спад vр при давлениях выше 0,8 Па связан с увеличением вероятности возвращения распыленных атомов на мишень в результате процессов обратной диффузии и обратного рассеяния (отражения) на атомах инертного газа. В процессах РИПН, когда распыление мишени происходит в смеси инертного и реактивного газов, vр в 3–5 раз ниже, что связано с образованием на поверхности мишени химического соединения частиц мишени и реактивного газа (оксида, нитрида, карбида и т. д.), коэффициент распыления которого всегда меньше нежели чистого материала мишени. Очевидно, что с ростом парциального давления реактивного газа vр падает.
Перенос распыленного вещества.
Процесс переноса распыленного материала от мишени до подложки зависит от средней энергии распыленных частиц, их углового распределения, давления рабочего газа p, расстояния между распыляемой и приемной поверхностями d, а также от наличия в некоторых случаях электрических и магнитных полей, определяющих движение ионизированных в плазме атомов распыленного материала. Для используемых на практике давлений p длина свободного пробега распыленных частиц не превышает нескольких мм, что всегда меньше расстояния d. Среднее число столкновений, после которых энергия распыленных атомов станет равной тепловой энергии атомов или молекул рабочего газа, а также длина направленного пробега Lp распыленных атомов, на которой они «погасят» свою избыточную энергию, зависят от соотношения масс распыленных атомов ma и частиц газа mг. Величина Lp растет с ростом ma и составляет при p = 0,5 Па от 3 до 15 см при распылении материалов от Al до Au в аргоне. Изменяя величины p и d, можно в достаточно широких пределах менять энергию конденсирующихся на подложке частиц, следовательно, характеристики пленки.
Формирование пленки.
Основными факторами, определяющими процесс формирования пленки при ИПН, являются энергия и величина потока конденсируемых и активирующих частиц, форма и взаимное расположения мишени и подложки, а также состав газовой смеси при РИПН. Благодаря зависимости энергии и потоков сталкивающихся с подложкой частиц от параметров газового разряда (напряжение и ток разряда, давление и состав рабочего газа), положения подложки и ее потенциала (смещения) относительно плазмы, возможности управления кинетикой образования и роста пленок, следовательно, свойствами пленок и характеристиками контакта пленка – подложка значительно шире, нежели в остальных методах осаждения.
Следует отметить, что процессы ИПН и РИПН относятся к низкотемпературным, т. е. температура подложки в процессе осаждения лежит в интервале 50–200 С в зависимости от условий процесса. Дополнительный нагрев подложки внешними источниками является еще одним фактором управления свойствами пленок.
Относительно высокая энергия конденсирующихся частиц и наличие активирующего воздействия на подложку (основной вклад вносит ионная бомбардировка) привели к следующим особенностям формирования пленок:
-
образование переходного слоя (ПС) на границе раздела пленка подложка;
-
сплошные пленки образуются при их минимальных толщинах, причем обладают меньшим размером зерен и большей плотностью, чем термически нанесенные;
-
рост пленки происходит при любой плотности потока конденсирующихся частиц на подложку.
Образование ПС, т. е. отсутствие резкой границы между материалом пленки и подложки, обусловлено как частичным внедрением распыленных частиц в подложку, так и высокой скоростью диффузии частиц пленки по радиационным дефектам поверхностного слоя подложки. Наличие ПС приводит к высокой адгезии пленки (адгезия – сила, которую нужно приложить к единице площади пленки, чтобы оторвать ее от подложки). Например, адгезия Al на SiO2 в 10 раз выше, чем для технологии термического нанесения. При образовании ПС происходит изменение электрофизических параметров контакта. Можно получить невыпрямляющие контакты к легированным полупроводникам без высокотемпературной обработки, снизить переходное сопротивление контакта. Указанные выше вторая и третья особенности формирования пленок при ИПН обусловлены активирующим воздействием плазмы, приводящим к высокой плотности зародышеобразования на поверхности подложки.
Применение ИПН и РИПН в технологии СБИС.
Ионно-плазменное нанесение нашло широкое применение практически на всех этапах изготовления СБИС при создании токопроводящих систем, диэлектрических и технологически вспомогательных покрытий. Остановимся на основных технологических аспектах ИПН и РИПН, связанных с требованиями к пленочным покрытиям СБИС.
Требование к комфорности покрытия удовлетворяют путем подачи на подложку отрицательного смещения в диапазоне 30200 В или путем предварительного нагрева подложки, а также в редких случаях осаждением в смесь Ar + H2. Бомбардировка растущей пленки ионами Ar или повышенная температура подложки стимулируют подвижность поверхностных атомов и, кроме этого, вследствие вторичного распыления происходит перераспределение осаждаемой пленки. Поскольку скорость вторичного распыления значительно выше для ионов, поступающих на подложку под малыми углами падения, чем для ионов, падающих под прямым углом, происходит удаление материала с выступающих частей. Таким образом, материал со дна ступеньки перераспределяется на стенки.
Наличие отрицательного смещения на подложке позволяет удалить с ее поверхности слабосвязанные молекулы адсорбированных газов, оксиды и другие загрязнения, что повышает адгезию пленки и степень загрязнений газовыми включениями.
Требования к минимуму внутренних механических напряжений пленок также можно удовлетворить подачей смещения. Изменяя величину смещения, можно получить как растягивающие, так и сжимающие напряжения. Смещение, при котором напряжения минимальны, строго индивидуально для данного металла и используемой системы осаждения. Кроме этого, величина и тип напряжения в пленке определяются давлением рабочего газа в процессе осаждения и в меньшей мере – скоростью осаждения. Например, при ИПН пленки Mo изменение p от 0,1 до 1 Па приводило к переходу от сжимающих, величиной 300 Н/м, до растягивающих, величиной 100 Н/м, напряжений. Нулевое значение напряжения получено при p=0,6 Па. Уменьшает внутренние напряжения в пленках Ti и W добавка N2 к Ar в количестве нескольких процентов. Одновременно такая добавка улучшает их барьерные свойства.
Технология ИПН полностью удовлетворяет требованиям к контактным и проводящим слоям, когда в качестве последних используются не только металлы, но и их сплавы (например, Al с Cu, Ti или Si) и силициды тугоплавких металлов. Для формирования покрытий из сплавов и силицидов обычно используется одновременное распыление нескольких мишеней и реже распыление композиционной мишени. При одновременном распылении мишеней содержание каждого элемента в пленке регулируют путем изменения мощности, прикладываемой к каждой мишени. Используя одновременное распыление, получают сплавы Cr-Ag, Ni-Ag и Cu-Ag. Эти сплавы сохраняют способность к пайке в течение нескольких недель при комнатной температуре, что позволяет применить низкотемпературную пайку кристаллов в корпус без облуживания благородным металлом. Получаемый одновременным распылением сплав Al-Cu-Si обладает высокой стойкостью к электромиграции и коррозии.
Барьерные слои с требуемыми свойствами на основе нитридов тугоплавких металлов (в основном Ti, Ta и Mo) осаждают по технологии РИПН, используя в качестве рабочего газа смесь Ar + N2. Состав покрытия регулируют путем изменения парциального давления азота, размер зерен – путем изменения температуры подложки и ее потенциала. На удельное сопротивление нитридов сильное влияние оказывает чистота рабочего газа. Например, наличие кислорода до 1 % приводит к росту удельного сопротивления TiN на порядок. При отсутствии O2 получены пленки TiN с удельным сопротивлением 20–80 мкОм·см – более низким, чем у пленок Ti.
При осаждении диэлектрических покрытий (например, оксидов в смеси Ar+O2) они могут содержать «захваченный» заряд, оказывающий отрицательное влияние на стабильность и срок службы МОП-приборов. Однако этот заряд можно эффективно устранить при помощи отжига диэлектрика в атмосфере азота при температуре 450 С. Значительно снизить плотность дефектов диэлектрика (поры, сквозные проколы) можно как правильным выбором содержания O2 в рабочем газе, так и подачей смещения на подложку.
Ионно-лучевое осаждение
Технология ионно-лучевого осаждения (ИЛО) имеет две модификации. Первая основана на физическом распылении поверхности мишени ионным лучом инертного газа автономного ионного источника (АИИ) и осаждении распыленного материала на подложку. Создается ионный луч с помощью АИИ. Вторая модификация сводится к прямому осаждению на подложку ионного луча, сформированного АИИ из требуемого материала покрытия. Прямое осаждение пленок из АИИ можно проводить только при малых энергиях осаждаемых частиц, поскольку с увеличением энергии начинается самораспыление. Это ограничивает плотность ионного тока, а следовательно, и возможности осаждения пленок на большие площади с требуемой скоростью. Тем не менее, имеются сведения о прямом осаждении эпитаксиальных пленок Si и Ge при энергиях ионов от 10 до 200 эВ. Процессы ИЛО реализуются в вакуумных камерах с давлением не больше 10-2 Па для исключения рассеяния ионного луча на частицах остаточной атмосферы.
Лекция 15
Спектрофотометрический оперативный контроль процессов формирования тонкопленочных покрытий различного назначения
Интерференция света в тонких пленках
Интерференция происходит между лучами света, отраженными от верхней и нижней поверхностей пленки (рис. 1).
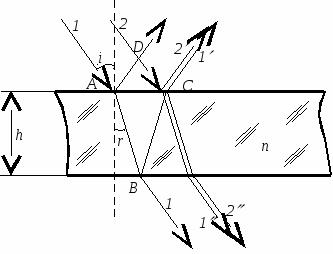
Рис. 1. Интерференция равной толщины
В отраженном свете интерферируют лучи 1 и 2, в проходящем свете – лучи 1 и 2. Для первых двух разность хода возникает при движении фронта волны на пути ABC для луча 1 и от точки D до C для луча 2. Оптическая длина пути равна
(AB + BC)n, где n – показатель преломления материала пленки. Разность хода определяется из уравнения
=n(AB+BC)–CD=2nh cos r, (1)
или
=2h(n2–sin2 i)1/2. (2)
Из опыта и теории известно, что при отражении света от границы среды с большим показателем преломления в среду с меньшим показателем преломления наблюдается дополнительный сдвиг (скачок) фазы, равный , чему соответствует изменение разности хода лучей 1 и 2 на половину длины волны /2; при этом максимумы будут наблюдаться в том случае, если разность хода будет равна нечетному числу полуволн:
=2nh cos r=(2k+1)/2. (3)
В проходящем свете максимумы будут наблюдаться при разности хода лучей, равной целому числу волн:
=2nh cos r=k. (4)
В отраженном свете интерференционная картина будет более контрастной, чем в проходящем, так как здесь интерферируют лучи равной интенсивности, а в минимумах – полное гашение света. От нижней поверхности, как и от верхней, отражается одинаковое количество падающего света (4–8%), а проходит около 90–85%. Поэтому в проходящем свете интерференция отраженного и прошедшего лучей различной интенсивности не дает в минимумах полного гашения.
Определение параметров пленок
При разработке методов расчета и контроля пленок основой служит модель идеальной пленки, аналогичной плоскопараллельной пластинке из однородного, непоглощающего вещества. Толщина ее мала по сравнению с окружающими средами. У экспериментально получаемых пленок наблюдаются заметные отклонения от простой модели. В зависимости от состояния исходного вещества и условий нанесения структура пленок может быть различной. Вещество в виде тонкой пленки может быть аморфным и кристаллическим. Кристаллическая структура может характеризоваться размером зерен и степенью их упорядоченности. Различные модификации одного и того же вещества могут иметь различные показатели преломления.
Пленка обычно содержит поры, величина и количество которых зависят от метода нанесения. Вследствие этого показатель преломления вещества пленки обычно ниже, чем вещества в массе. Пористость пленки можно характеризовать «коэффициентом заполнения», который представляет собой отношение каких-либо постоянных для вещества в виде пленки и в виде массы, например отношение их плотностей, показателей преломления и др. Коэффициент заполнения пленок почти всегда меньше единицы.
Экспериментально получаемые пленки в той или иной степени неоднородны, что необходимо учитывать при определении оптических постоянных, иначе это может служить причиной неправильного истолкования полученных результатов 3начительная неоднородность пленок может препятствовать применению обычных методов исследования. Все сказанное говорит о том, что совпадение теоретических и экспериментальных данных в значительной степени зависит от того, насколько близка реальная пленка к идеальной модели, лежащей в основе разрабатываемых методов. Наблюдаемые расхождения могут привести к ошибочным толкованиям, однако в ряде случаев, при внимательном рассмотрении, могут служить указанием на те особенности структуры, которые вызвали эти отклонения. Каждый метод наиболее четко отражает какую-либо сторону явления.
Наиболее объективное исследование требует параллельного применения различных методов следующих отношений:
n2 >< n3, n2h2=(2k+1)λ/4 или n2h2=2kλ/4 (24)

Рис. 2. Спектральное отражение от поверхности подложки (n2) с однородной пленкой (n3)
Экстремальное значение Rλ
 (25) (25)
дает возможность определить показатель преломления пленки
 . (26) . (26)
Спектральные кривые Rλ, по которым производится расчет характеристик пленок, получают в результате спектрофотометрических измерений коэффициента отражения (рис. 2). Через RМ, обозначено минимальное значение Rλ в том случае, когда n2< n3. и через RМ – максимальное, когда n2 > n3. Экстремальное значение
 (27) (27)
равное отражению поверхности подложки n3 (без учета дисперсии), будет максимальным в случае n2 < n3 и минимальным, когда n2 > n3. Оптическая толщина пленки находится из соотношения:
 (28) (28)
где λМ соответствует положениям RМ.
На оси абсцисс (рис. 2) приведены значения ряда длин волн выбранного спектрального участка: λ1, λ2, ..., λ7, где λ7 < λ1.
При изменении показателя преломления пленки в зависимости от длины волны высота максимумов для разных значений λ1, λ2, ..., λ7 в случае n2 > n3 и глубина минимумов в случае n2 < n3 будут различны. Положение экстремумов также не будет строго соответствовать длинам волн. Оптические среды в основном обладают нормальным ходом дисперсии, и показатель преломления растет с уменьшением длины волны; значит, глубина минимумов RМ1 будет уменьшаться, а высота максимумов RМ3 будет возрастать в указанном направлении. Соответственно и расстояния между экстремумами уменьшатся в результате увеличения эффективной оптической толщины пленки. Определение показателя преломления пленки для различных участков спектра можно осуществить проще и точнее, если пленка достаточно толста и в исследуемом спектральном интервале имеется несколько максимумов и минимумов.
Начинать измерения целесообразно в области, где дисперсия незначительна (по возможности дальше от полосы поглощения), и соседние экстремумы RМ1 и RМ3, имеют практически постоянные значения. Наличие минимумов или максимумов RМ1 или RМ3, в той области, где дисперсия значительна, дает возможность определить показатель преломления n2, соответствующий этим спектральным участкам. Смещение положения экстремумов в результате дисперсии дает возможность дополнительной проверки правильного определения зависимости n2, от длины волны, поскольку известна геометрическая толщина пленки. Анализ спектральных кривых дает возможность установить не только дисперсию вещества пленки. Значительные искажения вносят другие факторы и, в первую очередь, потери, вызванные рассеянием и поглощением в пленках.
Лекция 16
Взаимодействие высокоэнергетических потоков частиц с твердым телом
Ионная имплантация примеси
Физические процессы, происходящие при бомбардировке вещества ускоренными ионами
Пробеги частиц в твердом теле.
Каналирование и аморфизиция.
Радиационно-химические превращения в твердом теле, распыление
В настоящее время ионная имплантация, под которой понимают внедрение высокоэнергетических ионов в твердое тело, получила широкое распространение в различных областях науки и техники. Ее важнейшее применение связано с управлением проводимостью полупроводников путем бомбардировки их ионами определенного типа. Но, кроме этого, существуют и другие области использования ионного внедрения в современных технологиях: упрочнение металлов и сплавов, модификация оптических, механических, электрофизических и ряда других физико-химических поверхностных свойств материалов. Мы остановимся, в основном, на вопросах ионного легирования материалов электронной техники и в первую очередь – кремния. Однако изложенный здесь материал носит в достаточной степени общий характер и может быть легко перенесен на ионное легирование более сложных многокомпонентных материалов.
В современных технологиях изготовления ИС и особенно СБИС и УБИС ионная имплантация стала основным технологическим процессом внедрения примесей в различные функциональные слои. Распространение технологии ионной имплантации вызвано следующими ее достоинствами.
1. Позволяет получать высокооднородные и хорошо воспроизводимые профили концентрации внедряемой примеси, что достигается путем управления током пучка ионов и их энергией. Кроме того, технология ионного легирования дает возможность создать специальные формы профилей (полиэнергетическая ионная имплантация).
2. Прекрасно согласуется с планарной технологией изготовления ИС. Оксид кремния, используемый в качестве масок при диффузии, а также фоторезистом, можно применять и для маскирования ионного пучка.
3. Является низкотемпературным процессом за исключением ее специальных применений.
4. Позволяет внедрить в мишень ионы практически любого элемента периодической системы.
Естественно, технология ионного внедрения имеет и недостатки, главный из них – создание радиационных дефектов, которые обычно устраняются в ходе операции отжига.
ФИЗИЧЕСКИЕ ПРОЦЕССЫ, ПРОИСХОДЯЩИЕ
ПРИ БОМБАРДИРОВКЕ ВЕЩЕСТВА УСКОРЕННЫМИ ИОНАМИ
При ионной бомбардировке мишеней в качестве первичных частиц могут быть использованы отрицательно и положительно заряженные ионы (последние применяются наиболее часто из-за простоты их получения). Облучение может проводиться также молекулярными пучками (N2+, H2+) .
Двигаясь в твердом теле, быстрые заряженные частицы тормозятся в результате взаимодействия с электронной и атомной подсистемами вещества мишени. Принято различать следующие основные процессы, приводящие к потере энергии движущейся частицей:
• неупругие столкновения со связанными электронами, приводящие к ионизации атомов мишени;
• неупругие процессы взаимодействия с электронным газом в металлах и полупроводниках;
• неупругие столкновения с ядрами, вызывающие тормозное излучение, ядерные реакции или возбуждение ядер;
• упругие столкновения с атомами вещества, в результате которых часть их кинетической энергии передается атомам мишени.
Ограничимся рассмотрением диапазона энергии налетающих ионов, который реально используется в современных технологиях микроэлектроники: от десятков килоэлектрон-вольт (кэВ) до нескольких сотен кэВ. Доминирующими механизмами потерь энергии в данном случае будут являться упругое и неупругое взаимодействия с атомами мишени.
ПРОБЕГИ УСКОРЕННЫХ ИОНОВ В ТВЕРДОМ ТЕЛЕ
И ИХ РАСПРЕДЕЛЕНИЕ
Важнейшим параметром, необходимым для практического применения ионной имплантации, является величина пробега ионов в твердом теле. Из-за того, что число столкновений движущегося иона с атомами мишени носит случайный характер, траектории ионов и их пробеги в твердом теле будут отличаться друг от друга. Например, в определенных условиях некоторая часть ионов вообще отражается от мишени. Следовательно, мы должны при описании процесса ионной имплантации говорить не об индивидуальных траекториях, а о распределении ионов по пробегам, которое будем описывать функцией.
ИОННАЯ ИМПЛАНТАЦИЯ И ФИЗИЧЕСКОЕ РАСПЫЛЕНИЕ
При ионной имплантации примесей в полупроводники обычно используют невысокие дозы облучения и эффекты распыления поверхности мишени незначительны. Облучение высокими дозами ускоренных ионов средних и больших масс, особенно в диапазоне энергий 10–50 кэВ, приводит к значительному физическому распылению мишени. Поэтому в ряде задач необходимо уметь оценить, а во многих случаях и достаточно точно рассчитать коэффициент распыления мишени при ионной бомбардировке.
Коэффициент распыления (физического) при нормальном падении пучка ионов к поверхности мишени может быть рассчитан по формуле:
Yf =0,042 , (4.42) , (4.42)
где (M2/M1) – функция отношения масс, заданная таблично, Sn() – ядерная тормозная способность, U0 – поверхностная энергия связи, равная для кремния 7,83 эВ.
Как видно из формулы (4.42), зависимость коэффициента физического распыления от энергии налетающих частиц в рамках теории Зигмунда определяется вышерассмотренной зависимостью упругих потерь от энергии. Представление о типичных значениях коэффициента распыления кремния ионами, используемыми на практике при создании ИС, можно получить из табл. 4.5, в которой приведены рассчитанные методом Монте-Карло величины Yf при имплантации ионов бора, фосфора, мышьяка и сурьмы в кремний.
Таблица 4.5 Значения Yf при имплантации ионов B+, P+, As+ и Sb+ в кремний
E, кэВ
|
B
|
P
|
As
|
Sb
|
10
|
0,45
|
1,15
|
1,48
|
1,68
|
50
|
0,22
|
1,02
|
2,15
|
2,70
|
100
|
0,13
|
0,85
|
2,30
|
2,68
|
200
|
0,06
|
0,60
|
2,10
|
2,28
|
страница 1 | страница 2 страница 3
|