страница 1 ... страница 2 | страница 3 | страница 4 страница 5
Ионно-плазменное нанесение покрытий
Технология ионно-плазменного нанесения (ИПН) основана на процессе физического распыления поверхности материала (мишени), из которого необходимо создать пленку, ионами инертного газа, генерируемыми в контактирующей с распыляемым материалом низкотемпературной газоразрядной плазме. Поток распыленных частиц осаждается на приемную подложку, формируя пленочное покрытие. Процесс образования и роста пленки сопровождается бомбардировкой подложки атомами и ионами инертного газа, а также электронами и фотонами, т. е. стимулируется плазменным разрядом. Если плазма создана в смеси инертного и химически активного (реактивного) газов, то технологию называют реактивным ионно-плазменным нанесением (РИПН). В этом случае подложку кроме распыленных частиц и частиц инертного газа бомбардируют химически активные частицы (ХАЧ) или же ХАЧ образуются на самой подложке при диссоциации адсорбированных молекул реактивного газа под стимулирующим воздействием плазмы. Такие условия процесса приводят к формированию пленок химических соединений: оксидов, нитридов и карбидов материала мишени.
Простейшим устройством для реализации технологии ИПН является диодная система с тлеющим разрядом на постоянном токе. Распыляемым материалом является материал катода. Подложки могут быть расположены как на аноде, так и на боковых стенках разрядной камеры.
Физические процессы, сопровождающие ИПН, можно разделить на три группы: процессы распыления поверхности мишени, процессы переноса распыленного материала к поверхности подложки и процессы формирования пленки на подложке. Рассмотрим эти процессы и их влияние на свойства осаждаемых покрытий.
Распыление мишени.
Первоначально в технологии ИПН и РИПН были распространены диодные системы на постоянном токе для распыления металлов и полупроводников, а также на ВЧ-токе для распыления диэлектрических мишеней. Широкое промышленное внедрение таких систем ограничивалось низкими скоростями распыления и, следовательно, малыми скоростями осаждения 0,2–2 нм/с, высоким напряжением горения разряда 2–5 кВ и высоким рабочим давлением 1–10 Па, что снижало производительность технологии и препятствовало получению пленок с минимальным уровнем загрязнений и радиационных дефектов. Положение коренным образом изменилось после появления магнетронных распылительных систем (МРС) – диодных систем, в которых у поверхности мишени создавалось магнитное поле, перпендикулярное электрическому. Взаимодействие полей в сочетании с формой распыляемой поверхности создает такую конфигурацию магнитных ловушек для электронов, при которой токи дрейфа электронов замыкаются на себя. Это обеспечивает высокую степень ионизации газа в МРС, т.е. высокую плотность ионного потока на мишень и, как следствие, повышение vр не менее чем на порядок, снижение напряжения горения разряда до 0,3–0,8 кВ и давления до 0,1–1 Па, что увеличило чистоту наносимой пленки и снизило радиационные повреждения подложки и пленки.
Главным фактором, ограничивающим vр, является максимальный поток мощности, который может быть подан на мишень, не вызывая ее плавления, растрескивания или сублимации. Для металлов с хорошей теплопроводностью допустимая плотность мощности определяется возможностями водяного охлаждения мишени и может составлять до сотен Вт/см2, что соответствует скорости распыления 1–5 мкм/мин.
В отличие от процесса термического нанесения, при котором средняя энергия испаренных частиц составляет доли эВ, средняя энергия распыленных частиц Eр лежит в диапазоне 10–90 эВ, основная часть этих частиц имеет энергию 3–15 эВ. В энергетическом спектре распыленных частиц наблюдается также высокоэнергетический хвост в сотни эВ, однако количество таких частиц относительно мало и не превышает одного процента. Для используемых обычно мишеней из поликристаллических материалов угловое распределение распыленных атомов при напряжениях, близких к 1 кВ, в первом приближении описывается законом косинуса. При снижении напряжения до 0,4–0,5 кВ наблюдается «подкосинусное» распределение распыленных атомов, когда большее число частиц распыляется параллельно поверхности мишени и меньшее – перпендикулярно. Скорость распыления возрастает с увеличением мощности разряда и имеет максимум в зависимости от давления инертного газа. Максимум vр достигается при давлениях 0,5–0,8 Па. Рост vр с изменением давления от 0,1 до 0,5 Па обусловлен ростом плотности ионного потока на поверхность мишени. Спад vр при давлениях выше 0,8 Па связан с увеличением вероятности возвращения распыленных атомов на мишень в результате процессов обратной диффузии и обратного рассеяния (отражения) на атомах инертного газа. В процессах РИПН, когда распыление мишени происходит в смеси инертного и реактивного газов, vр в 3–5 раз ниже, что связано с образованием на поверхности мишени химического соединения частиц мишени и реактивного газа (оксида, нитрида, карбида и т. д.), коэффициент распыления которого всегда меньше нежели чистого материала мишени. Очевидно, что с ростом парциального давления реактивного газа vр падает.
Перенос распыленного вещества.
Процесс переноса распыленного материала от мишени до подложки зависит от средней энергии распыленных частиц, их углового распределения, давления рабочего газа p, расстояния между распыляемой и приемной поверхностями d, а также от наличия в некоторых случаях электрических и магнитных полей, определяющих движение ионизированных в плазме атомов распыленного материала. Для используемых на практике давлений p длина свободного пробега распыленных частиц не превышает нескольких мм, что всегда меньше расстояния d. Среднее число столкновений, после которых энергия распыленных атомов станет равной тепловой энергии атомов или молекул рабочего газа, а также длина направленного пробега Lp распыленных атомов, на которой они «погасят» свою избыточную энергию, зависят от соотношения масс распыленных атомов ma и частиц газа mг. Величина Lp растет с ростом ma и составляет при p = 0,5 Па от 3 до 15 см при распылении материалов от Al до Au в аргоне. Изменяя величины p и d, можно в достаточно широких пределах менять энергию конденсирующихся на подложке частиц, следовательно, характеристики пленки.
Формирование пленки.
Основными факторами, определяющими процесс формирования пленки при ИПН, являются энергия и величина потока конденсируемых и активирующих частиц, форма и взаимное расположения мишени и подложки, а также состав газовой смеси при РИПН. Благодаря зависимости энергии и потоков сталкивающихся с подложкой частиц от параметров газового разряда (напряжение и ток разряда, давление и состав рабочего газа), положения подложки и ее потенциала (смещения) относительно плазмы, возможности управления кинетикой образования и роста пленок, следовательно, свойствами пленок и характеристиками контакта пленка – подложка значительно шире, нежели в остальных методах осаждения.
Следует отметить, что процессы ИПН и РИПН относятся к низкотемпературным, т. е. температура подложки в процессе осаждения лежит в интервале 50–200 С в зависимости от условий процесса. Дополнительный нагрев подложки внешними источниками является еще одним фактором управления свойствами пленок.
Относительно высокая энергия конденсирующихся частиц и наличие активирующего воздействия на подложку (основной вклад вносит ионная бомбардировка) привели к следующим особенностям формирования пленок:
-
образование переходного слоя (ПС) на границе раздела пленка подложка;
-
сплошные пленки образуются при их минимальных толщинах, причем обладают меньшим размером зерен и большей плотностью, чем термически нанесенные;
-
рост пленки происходит при любой плотности потока конденсирующихся частиц на подложку.
Образование ПС, т. е. отсутствие резкой границы между материалом пленки и подложки, обусловлено как частичным внедрением распыленных частиц в подложку, так и высокой скоростью диффузии частиц пленки по радиационным дефектам поверхностного слоя подложки. Наличие ПС приводит к высокой адгезии пленки (адгезия – сила, которую нужно приложить к единице площади пленки, чтобы оторвать ее от подложки). Например, адгезия Al на SiO2 в 10 раз выше, чем для технологии термического нанесения. При образовании ПС происходит изменение электрофизических параметров контакта. Можно получить невыпрямляющие контакты к легированным полупроводникам без высокотемпературной обработки, снизить переходное сопротивление контакта. Указанные выше вторая и третья особенности формирования пленок при ИПН обусловлены активирующим воздействием плазмы, приводящим к высокой плотности зародышеобразования на поверхности подложки.
Применение ИПН и РИПН в технологии СБИС.
Ионно-плазменное нанесение нашло широкое применение практически на всех этапах изготовления СБИС при создании токопроводящих систем, диэлектрических и технологически вспомогательных покрытий. Остановимся на основных технологических аспектах ИПН и РИПН, связанных с требованиями к пленочным покрытиям СБИС.
Требование к комфорности покрытия удовлетворяют путем подачи на подложку отрицательного смещения в диапазоне 30200 В или путем предварительного нагрева подложки, а также в редких случаях осаждением в смесь Ar + H2. Бомбардировка растущей пленки ионами Ar или повышенная температура подложки стимулируют подвижность поверхностных атомов и, кроме этого, вследствие вторичного распыления происходит перераспределение осаждаемой пленки. Поскольку скорость вторичного распыления значительно выше для ионов, поступающих на подложку под малыми углами падения, чем для ионов, падающих под прямым углом, происходит удаление материала с выступающих частей. Таким образом, материал со дна ступеньки перераспределяется на стенки.
Наличие отрицательного смещения на подложке позволяет удалить с ее поверхности слабосвязанные молекулы адсорбированных газов, оксиды и другие загрязнения, что повышает адгезию пленки и степень загрязнений газовыми включениями.
Требования к минимуму внутренних механических напряжений пленок также можно удовлетворить подачей смещения. Изменяя величину смещения, можно получить как растягивающие, так и сжимающие напряжения. Смещение, при котором напряжения минимальны, строго индивидуально для данного металла и используемой системы осаждения. Кроме этого, величина и тип напряжения в пленке определяются давлением рабочего газа в процессе осаждения и в меньшей мере – скоростью осаждения. Например, при ИПН пленки Mo изменение p от 0,1 до 1 Па приводило к переходу от сжимающих, величиной 300 Н/м, до растягивающих, величиной 100 Н/м, напряжений. Нулевое значение напряжения получено при p=0,6 Па. Уменьшает внутренние напряжения в пленках Ti и W добавка N2 к Ar в количестве нескольких процентов. Одновременно такая добавка улучшает их барьерные свойства.
Технология ИПН полностью удовлетворяет требованиям к контактным и проводящим слоям, когда в качестве последних используются не только металлы, но и их сплавы (например, Al с Cu, Ti или Si) и силициды тугоплавких металлов. Для формирования покрытий из сплавов и силицидов обычно используется одновременное распыление нескольких мишеней и реже распыление композиционной мишени. При одновременном распылении мишеней содержание каждого элемента в пленке регулируют путем изменения мощности, прикладываемой к каждой мишени. Используя одновременное распыление, получают сплавы Cr-Ag, Ni-Ag и Cu-Ag. Эти сплавы сохраняют способность к пайке в течение нескольких недель при комнатной температуре, что позволяет применить низкотемпературную пайку кристаллов в корпус без облуживания благородным металлом. Получаемый одновременным распылением сплав Al-Cu-Si обладает высокой стойкостью к электромиграции и коррозии.
Барьерные слои с требуемыми свойствами на основе нитридов тугоплавких металлов (в основном Ti, Ta и Mo) осаждают по технологии РИПН, используя в качестве рабочего газа смесь Ar + N2. Состав покрытия регулируют путем изменения парциального давления азота, размер зерен – путем изменения температуры подложки и ее потенциала. На удельное сопротивление нитридов сильное влияние оказывает чистота рабочего газа. Например, наличие кислорода до 1 % приводит к росту удельного сопротивления TiN на порядок. При отсутствии O2 получены пленки TiN с удельным сопротивлением 20–80 мкОм·см – более низким, чем у пленок Ti.
При осаждении диэлектрических покрытий (например, оксидов в смеси Ar+O2) они могут содержать «захваченный» заряд, оказывающий отрицательное влияние на стабильность и срок службы МОП-приборов. Однако этот заряд можно эффективно устранить при помощи отжига диэлектрика в атмосфере азота при температуре 450 С. Значительно снизить плотность дефектов диэлектрика (поры, сквозные проколы) можно как правильным выбором содержания O2 в рабочем газе, так и подачей смещения на подложку.
Ионно-лучевое осаждение
Технология ионно-лучевого осаждения (ИЛО) имеет две модификации. Первая основана на физическом распылении поверхности мишени ионным лучом инертного газа автономного ионного источника (АИИ) и осаждении распыленного материала на подложку. Создается ионный луч с помощью АИИ. Вторая модификация сводится к прямому осаждению на подложку ионного луча, сформированного АИИ из требуемого материала покрытия. Прямое осаждение пленок из АИИ можно проводить только при малых энергиях осаждаемых частиц, поскольку с увеличением энергии начинается самораспыление. Это ограничивает плотность ионного тока, а следовательно, и возможности осаждения пленок на большие площади с требуемой скоростью. Тем не менее, имеются сведения о прямом осаждении эпитаксиальных пленок Si и Ge при энергиях ионов от 10 до 200 эВ. Процессы ИЛО реализуются в вакуумных камерах с давлением не больше 10-2 Па для исключения рассеяния ионного луча на частицах остаточной атмосферы.
Осаждение пленок путем распыления мишеней с помощью АИИ по сравнению с термовакуумной технологией позволяет существенно улучшить свойства пленок, так как энергия осаждающихся частиц лежит в диапазоне от единиц до десятков эВ и не снижается в процессе получения пленок, поскольку процесс происходит в высоком вакууме. Для получения пленок оксидов или нитридов ионное распыление может быть реализовано в присутствии O2 или N2. Состав и структура таких пленок изменяются в зависимости от концентрации реактивного газа и энергии осаждаемых частиц.
Технология ИЛО не нашла широкого применения в производстве СБИС. Основные причины – высокие радиационные повреждения подложки, низкие скорости осаждения из-за отсутствия сильноточных АИИ и значительно меньшая гибкость в управлении свойствами осаждаемых покрытий.
Лекция 16
Основы спектрофотометрии пленок
Интерференция света в тонких пленках
Интерференция происходит между лучами света, отраженными от верхней и нижней поверхностей пленки (рис. 1).
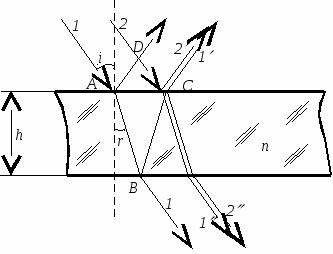
Рис. 1. Интерференция равной толщины
В отраженном свете интерферируют лучи 1 и 2, в проходящем свете – лучи 1 и 2. Для первых двух разность хода возникает при движении фронта волны на пути ABC для луча 1 и от точки D до C для луча 2. Оптическая длина пути равна
(AB + BC)n, где n – показатель преломления материала пленки. Разность хода определяется из уравнения
=n(AB+BC)–CD=2nh cos r, (1)
или
=2h(n2–sin2 i)1/2. (2)
Из опыта и теории известно, что при отражении света от границы среды с большим показателем преломления в среду с меньшим показателем преломления наблюдается дополнительный сдвиг (скачок) фазы, равный , чему соответствует изменение разности хода лучей 1 и 2 на половину длины волны /2; при этом максимумы будут наблюдаться в том случае, если разность хода будет равна нечетному числу полуволн:
=2nh cos r=(2k+1)/2. (3)
В проходящем свете максимумы будут наблюдаться при разности хода лучей, равной целому числу волн:
=2nh cos r=k. (4)
В отраженном свете интерференционная картина будет более контрастной, чем в проходящем, так как здесь интерферируют лучи равной интенсивности, а в минимумах – полное гашение света. От нижней поверхности, как и от верхней, отражается одинаковое количество падающего света (4–8%), а проходит около 90–85%. Поэтому в проходящем свете интерференция отраженного и прошедшего лучей различной интенсивности не дает в минимумах полного гашения.
Определение параметров пленок
При разработке методов расчета и контроля пленок основой служит модель идеальной пленки, аналогичной плоскопараллельной пластинке из однородного, непоглощающего вещества. Толщина ее мала по сравнению с окружающими средами. У экспериментально получаемых пленок наблюдаются заметные отклонения от простой модели. В зависимости от состояния исходного вещества и условий нанесения структура пленок может быть различной. Вещество в виде тонкой пленки может быть аморфным и кристаллическим. Кристаллическая структура может характеризоваться размером зерен и степенью их упорядоченности. Различные модификации одного и того же вещества могут иметь различные показатели преломления.
Пленка обычно содержит поры, величина и количество которых зависят от метода нанесения. Вследствие этого показатель преломления вещества пленки обычно ниже, чем вещества в массе. Пористость пленки можно характеризовать «коэффициентом заполнения», который представляет собой отношение каких-либо постоянных для вещества в виде пленки и в виде массы, например отношение их плотностей, показателей преломления и др. Коэффициент заполнения пленок почти всегда меньше единицы.
Экспериментально получаемые пленки в той или иной степени неоднородны, что необходимо учитывать при определении оптических постоянных, иначе это может служить причиной неправильного истолкования полученных результатов 3начительная неоднородность пленок может препятствовать применению обычных методов исследования. Все сказанное говорит о том, что совпадение теоретических и экспериментальных данных в значительной степени зависит от того, насколько близка реальная пленка к идеальной модели, лежащей в основе разрабатываемых методов. Наблюдаемые расхождения могут привести к ошибочным толкованиям, однако в ряде случаев, при внимательном рассмотрении, могут служить указанием на те особенности структуры, которые вызвали эти отклонения. Каждый метод наиболее четко отражает какую-либо сторону явления.
Наиболее объективное исследование требует параллельного применения различных методов следующих отношений:
n2 >< n3, n2h2=(2k+1)λ/4 или n2h2=2kλ/4 (24)

Рис. 2. Спектральное отражение от поверхности подложки (n2) с однородной пленкой (n3)
Экстремальное значение Rλ
 (25) (25)
дает возможность определить показатель преломления пленки
 . (26) . (26)
Спектральные кривые Rλ, по которым производится расчет характеристик пленок, получают в результате спектрофотометрических измерений коэффициента отражения (рис. 2). Через RМ, обозначено минимальное значение Rλ в том случае, когда n2< n3. и через RМ – максимальное, когда n2 > n3. Экстремальное значение
 (27) (27)
равное отражению поверхности подложки n3 (без учета дисперсии), будет максимальным в случае n2 < n3 и минимальным, когда n2 > n3. Оптическая толщина пленки находится из соотношения:
 (28) (28)
где λМ соответствует положениям RМ.
На оси абсцисс (рис. 2) приведены значения ряда длин волн выбранного спектрального участка: λ1, λ2, ..., λ7, где λ7 < λ1.
При изменении показателя преломления пленки в зависимости от длины волны высота максимумов для разных значений λ1, λ2, ..., λ7 в случае n2 > n3 и глубина минимумов в случае n2 < n3 будут различны. Положение экстремумов также не будет строго соответствовать длинам волн. Оптические среды в основном обладают нормальным ходом дисперсии, и показатель преломления растет с уменьшением длины волны; значит, глубина минимумов RМ1 будет уменьшаться, а высота максимумов RМ3 будет возрастать в указанном направлении. Соответственно и расстояния между экстремумами уменьшатся в результате увеличения эффективной оптической толщины пленки. Определение показателя преломления пленки для различных участков спектра можно осуществить проще и точнее, если пленка достаточно толста и в исследуемом спектральном интервале имеется несколько максимумов и минимумов.
Начинать измерения целесообразно в области, где дисперсия незначительна (по возможности дальше от полосы поглощения), и соседние экстремумы RМ1 и RМ3, имеют практически постоянные значения. Наличие минимумов или максимумов RМ1 или RМ3, в той области, где дисперсия значительна, дает возможность определить показатель преломления n2, соответствующий этим спектральным участкам. Смещение положения экстремумов в результате дисперсии дает возможность дополнительной проверки правильного определения зависимости n2, от длины волны, поскольку известна геометрическая толщина пленки. Анализ спектральных кривых дает возможность установить не только дисперсию вещества пленки. Значительные искажения вносят другие факторы и, в первую очередь, потери, вызванные рассеянием и поглощением в пленках.
страница 1 ... страница 2 | страница 3 | страница 4 страница 5
|